冯垚荣(电子科技大学,四川 成都 610054)
摘 要:经过剖析低压MOS中存在的漏电途径,针对高压LDMOS面积大,最小宽长比有约束的特色,提出了一种愈加适用于高压LDMOS的新式抗总剂量辐照结构。器材仿真成果显现,新结构在完成500 krad(Si)的抗辐照才能,并且新结构不会添加面积耗费,与现有工艺彻底兼容。
要害词:总剂量效应;高压LDMOS;抗辐照加固;辐射致漏电途径
0 导言
LDMOS(横向分散金属氧化物半导体)比较一般的MOSFET具有高耐压、高增益等长处,被广泛运用于各种电源办理电路中。高压LDMOS在芯片中要占到1/3更多的面积,所以说LDMOS的功用好坏关于电源办理电路至关重要。在太空等特种运用环境中,高能粒子长时间效果于MOSFET会使其电特性产生改动,具体体现为阈值电压漂移,关态漏电流增大,迁移率下降等功用退化。这些改动将显着影响电子设备的寿数,导致其功耗增大,乃至功用失效,这便是总剂量效应。因为电源电路功用的特殊性,无法像数字电路那样,选用冗余规划的办法完成抗辐照功用,这就要求电路自身,尤其是LDMOS有必要具有抗辐照的功用 [1] 。现在国内外关于LDMOS抗辐照规划的研讨,特别是600 V以上的高压LDMOS的研讨还比较少,大多还停留在沿袭低压MOS抗辐照规划计划的阶段 [2-3] 。
1 总剂量效应机理及辐照导致的寄生漏电途径
1.1 总剂量效应的机理简介
总剂量效应是辐照致电路失效的一种长时间机制,它首要效果于MOSFET中的氧化物部分。其机理能够简述为:高能粒子的炮击使MOSFET氧化层中产生电子-空穴对,因为电子与空穴迁移率的差异,在偏压的效果下,电子很快就被扫出氧化层;而空穴则被缓慢的输运到氧化物/体硅界面,输运过程中空穴若被氧化物中的空穴圈套抓获就会构成氧化层圈套电荷,跟着辐照总剂量的添加,这些圈套电荷的数量也越来越多,其终究的成果便是在氧化层内部以及氧化物/体硅界面产生净的正电荷,导致MOSFET的阈值电压漂移和关态漏电流增大 [4] 。总剂量效应在MOSFET氧化层的体内和氧化物/体硅界面产生净的正电荷,因而N型MOSFET对总剂量效应更为灵敏,接下来都只评论NMOS中的总剂量效应。
1.2 一般低压NMOS中的寄生漏电途径与抗总剂量辐照规划
总剂量效应导致MOSFET阈值电压漂移和关态漏电流增大,其本质是氧化层固定正电荷堆集到必定程度,使下方的p型层产生了反型,构成了无法关断的寄生漏电通路,关于一般低压NMOS,存在如图1所示的两种或许存在的漏电途径。第一种源漏间的漏电途径如图1(a)的箭头所示,它产生在MOSFET的有源区与场区接壤的沟道处,固定电荷导致接壤处的沟道反型,构成寄生沟道,当NMOS源漏有偏压存在时,即便栅压低于阈值电压也会有电流产生;第二种晶体管间的漏电途径如图1(b)的箭头所示,它产生在两个晶体管之间,辐照使场氧失掉了阻隔效果,在NMOS的源/漏与PMOS的N阱之间构成了寄生导电途径,PMOS的N阱一般固定接较高的电位,会使漏电一向存在 [4] 。
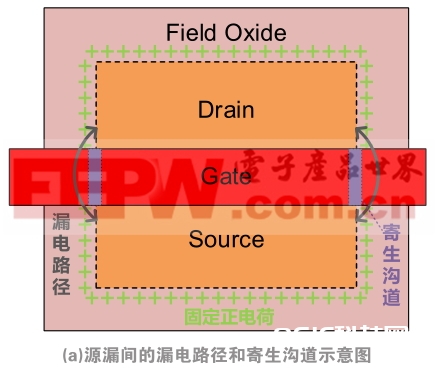
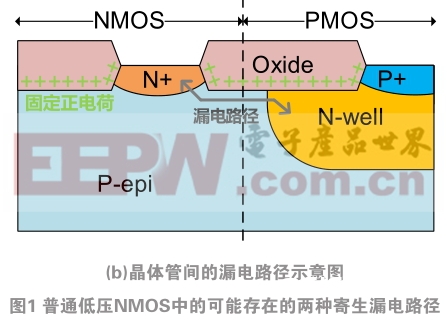
一般NMOS的抗总剂量规划遍及选用环栅地图结构,环栅结构将导电沟道与场氧区彻底分隔,因而彻底避免了源漏间漏电通路的产生。环栅结构被证明有着杰出的抗总剂量效果 [5-7] ,可是环栅地图规划也存在着比如器材面积大,宽长比无法自在选取等缺陷。
1.3 高压LDMOS中的寄生漏电途径
如图2所示的是一种典型的高压NLDMOS的剖面图,比较图1能够直观地看出高压LDMOS与传统MOS的最大不同在于多出了一个漂移区的结构,这个结构首要起到提高器材耐压的效果,而便是这个差异给高压LDMOS的抗总剂量规划带来了很大不同。高压LDMOS在电路中要承受600 V乃至更高的电压,所以漂移区面积有必要做得很大,然后导致高压LDMOS的面积占到这个芯片面积的1/3以上。自身面积巨大,再改为环栅规划,所带来的本钱提高或许无法承受,咱们将在后文中剖析这个面积提高终究有多大。
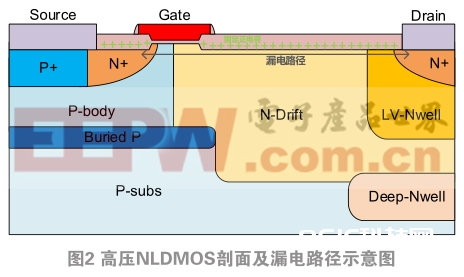
比较低压MOS,高压LDMOS还有两点不同之处:一是LDMOS的栅氧要比低压MOS厚,因而LDMOS的栅氧对总剂量效应愈加灵敏,但一同LDMOS的阈值也较低压MOS高,因而可承受的阈值漂移的量也更大。关于要求较高的规划咱们能够选用在栅氧成长时掺氟等工艺来提高栅氧的抗总剂量才能 [8] 。二是高压LDMOS并不存在上文所述的第二种漏电途径,为了避免施加在LDMOS上的高压对相邻器材形成串扰,会在LDMOS的四周加上一圈P+阻隔环,这个阻隔环刚好也能起到根绝管间漏电途径产生的效果。经过以上的剖析咱们可知,高压LDMOS自身的面积现已很大,因而不适合选用传统的环栅结构完成抗辐照功用,也不存在第二种漏电途径,所以咱们在规划运用与高压LDMOS的抗辐照结构时,应该着眼于消除源漏间的漏电通路。
1.4 新式抗总剂量辐照高压LDMOS结构
依据前面所做的比照和剖析,本文提出了一种新式抗总剂量辐照高压LDMOS结构,在消除源漏间漏电通路的一同,比较原LDMOS结构面积没有任何添加。图3是新式抗总剂量辐照高压LDMOS结构(以下简称新结构)与一般高压LDMOS结构的比照图,从图中能够看到,新结构将传统LDMOS的有源区和P-body的P+触摸向外延伸。向外延伸的有源区使得场氧远离LDMOS的沟道区,多出的P+掺杂区域向外横向分散,使得平等辐照剂量下场氧下的衬底不产生反型,然后避免了源漏间漏电通路的产生。
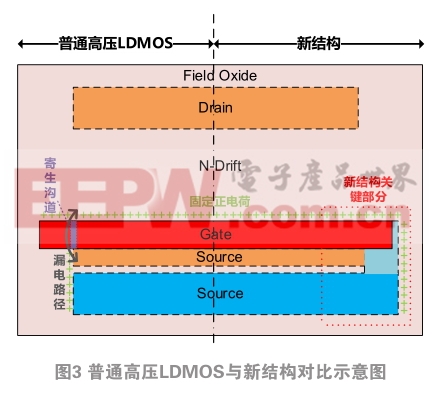

表1列出了相平等效宽长比条件下,传统、环栅结构和新式结构高压LDMOS的面积比较。三种结构的面积均是参阅国内某高压BCD工艺渠道的规划规矩给出,其间环栅等效宽长比核算用的是(W 1 +W 2 )/2的公式 [9] ,从表中能够看出环栅结构的面积是其他两种结构面积的7.5倍多,前面说到高压LDMOS在芯片中占到芯片总面积的1/3以上,照这个份额预算,假如选用环栅结构,芯片面积会在传统规划的基础上添加218%,这会大大添加电路的本钱,乃至或许导致芯片无法选用本来的封装计划。反观新结构就彻底不存在这方面的问题,新结构比较传统LDMOS结构,面积彻底没有添加,并且不添加新的掩膜版,能够与现有的工艺彻底兼容,不改动原有器材的耐压结构,不会形成生产本钱的添加。
2 新结构抗辐照才能仿真验证
2.1 仿真战略
本文经过Synopsys公司的Sentaurus TCAD软件对新结构的抗辐照功用进行仿真验证,运用软件自带的Insulator Fixed Charge模型,在资料接壤面设置固定正电荷来模仿总剂量效应对MOSFET的效果,该仿真办法现已被许多报导选用并验证过其可行性 [10-11] 。要验证新结构是否的确能够消除源漏间漏电途径,有必要进行3D仿真,3D仿真自身核算量很大,加之LDMOS比较一般MOS尺度巨大,经过屡次测验发现无法一同对整个LDMOS总剂量仿真。终究只选取LDMOS中受辐照影响会产生漏电通路的要害部分来进行仿真,如图4所示的便是本文终究树立的LDMOS仿真模型,从剖面图能够看到其依然包括LDMOS的一切要害结构,因而不影响仿真成果的可信度。相同出于减小核算量的考虑,咱们只在图4虚线框所示区域的Oxide/Si界面中参加固定电荷。固定电荷的密度参阅文献 [12] ,其经过将仿真成果与试验比照得知,2.93×1012/cm 2 的固定正电荷密度适当于剂量为300 krad(Si)的γ射线辐照;3.26×1012/cm 2的固定正电荷密度适当于剂量500 krad(Si)的γ射线辐照。本文仿真时共设置了8个不同固定电荷面密度,其间3.5×10 10 /cm 2 的密度用以表征器材出厂自带的正电荷,即未受辐照的状况,然后从0.5×10 12 /cm 2 开端,每隔0.5×10 12 /cm 2 的步长进行一次仿真,一向仿真到3.5×10 12 /cm 2 的面密度,保证仿真所施加的最大剂量高于500 krad(Si),并且能够调查跟着剂量的添加,器材的功用是怎么改动的。
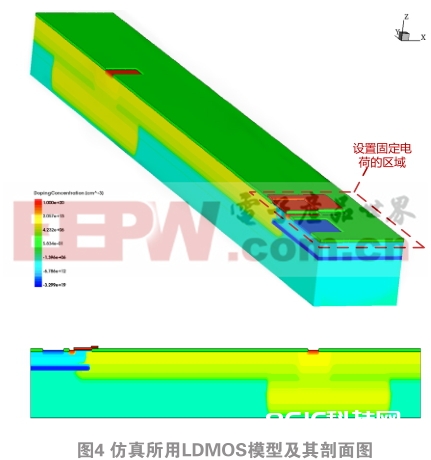
2.2 仿真成果及剖析
如图5所示的是一般高压LDMOS在不同电荷面密度下的搬运特性曲线的仿真成果,仿真施加的偏置条件为,Vds=0.1 V,Vb=Vs=0 V,Vg从-4 V扫描到10 V。从仿真成果咱们能够看到跟着电荷密度的添加,LDMOS的关态漏电流也随之添加,并且阈值电压也随之产生负向漂移,这与咱们之前说到的源漏间漏电通路会一同形成关态漏电流添加和阈值电压漂移的推论共同。未经辐照加固规划的高压LDMOS对总剂量效应适当灵敏,仅在1.0×10 12 /cm 2 的电荷密度就体现出了显着的漏电流添加,可见未加固的LDMOS其抗辐照才能远低于50 krad(Si)。而固定电荷密度添加到2.0×10 12 /cm 2以上时,关态漏电流简直现已与开态电流适当,此刻器材现已无法关闭彻底失掉功用。
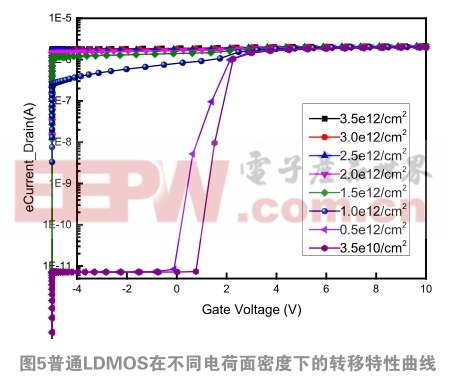
如图6所示的是本文提出的新式抗总剂量LDMOS在不同电荷面密度下的搬运特性曲线的仿真成果,仿真施加的偏置条件与一般LDMOS相同。从仿真成果咱们能够看到,跟着电荷密度的添加,LDMOS的关态漏电流没有显着改动,阈值电压也没有产生漂移,8条搬运特性曲线简直重合到了一同。阐明本文提出的新结构很好地消除了源漏间的漏电途径,参加抗辐照规划之后,LDMOS的抗辐照才能达到了500 krad(Si)以上。
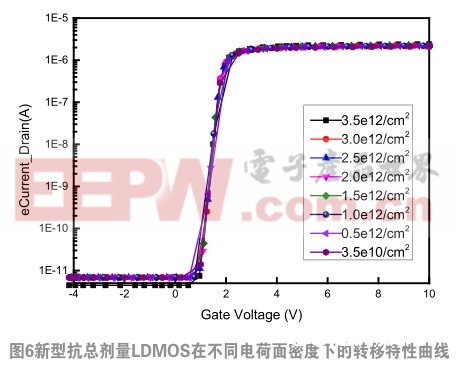
3 定论
本文结合对一般MOS总剂量效应的研讨,剖析了高压LDMOS与一般MOS在抗辐照规划方面的差异,提出了一种愈加适用于高压LDMOS新式抗总剂量结构,比较环栅结构,其不添加器材地图面积,不改动器材耐压,宽长比能够依照一般LDMOS的规矩选取,并且与现有的工艺彻底兼容。经过仿真验证,新结构的确能够有效地消除LDMOS中的漏电途径,完成 500 krad(Si)
以上的抗辐照才能。
参阅文献
[1]NAGORNOV A, TIMOSHENKOV V. Dependence of HVMOS transistor I-V characteristics from total ionizing doseeffects. 2018 IEEE Conference of Russian Young Researchers inElectrical and Electronic Engineering (EIConRus), 2018, 1996-1999.
[2]王丹辉,赵元富,岳素格,等.高压LDMOS总剂量辐射效应研讨[J].微电子学与核算机,2015,32(10):82-86.
[3]DODD P E, SHANEYFELT M R, DRAPER B L, et al.Developmentof a Radiation-Hardened Lateral Power MOSFET for POLApplications. IEEE Trans. Nucl. Sci., 2009,56:3456-3462.
[4]SCHWANK J R, SHANEYFELT M R, FLEETWOOD D M, et al.Radiation Effects in MOS Oxides. IEEE Transactions on NuclearScience,2008,55(4).
[5]范雪,李威,李平,等.根据环形栅和半环形栅N沟道金属氧化物半导体晶体管的总剂量辐射效应研讨[J].物理学报,2012,61(01):318-323.
[6]FACCIO F, CERVELLI G. Radiation-induced edge effectsin deepsubmicron CMOS transistors. IEEE Trans. Nucl. Sci.,2005,52(6): 2413 –2420.
[7]FACCIO F. “Design hardening methodologies for ASICs”in Radiation Effects on Embedded Systems. New York:Springer-Verlag,2007: 143-160,.
[8]谭开洲. MOS器材总剂量辐射加固技术研讨[D].成都:电子科技大学, 2001.
[9]杨变霞. 关闭形栅NMOS晶体管的规划与器材特性研讨[D].成都:电子科技大学, 2015.
[10]李念龙,于奇,王凯,等. MOS结构γ总剂量效应仿真模型研讨[J].微电子学,2013,43(03):445-448.
[11]Roh Y T, Lee H C. TID and SEE hardened n-MOSFET layouton a bulk silicon substrate which combines a DGA n-MOSFETand a guard drain. 2015 IEEE Nuclear Science Symposium andMedical Imaging Conference,1-4.2015.
[12]Lee M S, Lee H C.cDummy Gate-Assisted n-MOSFET Layoutfor a Radiation-Tolerant Integrated Circuit. IEEE Trans. Nucl. Sci.,2013,60(4):3084-3091.
本文来源于科技期刊《电子产品世界》2019年第11期第58页,欢迎您写论文时引证,并注明出处。









