导读:20世纪90年代跟着技能的前进,芯片集成度不断提高,I/O引脚数急剧添加,功耗也随之增大,对集成电路封装的要求也愈加严厉。为了满意开展的需求,BGA封装开端被应用于出产。下面咱们一同学习一下BGA到底是一个什么东西吧!
1.BGA是什么–简介
BGA的全称是Ball Grid Array(球栅阵列结构的PCB),是一种大型组件的引脚封装方法,与 QFP的四面引脚类似,都是使用SMT锡膏焊接与电路板相连。其不同处是罗列在四周的"一度空间"单排式引脚,如鸥翼形伸脚、平伸脚、或缩回腹底的J型脚等;改变成腹底全面数组或部分数组,采行二度空间面积性的焊锡球脚散布,做为芯片封装体对电路板的焊接互连东西。它具有封装面积少,功用加大,引脚数目增多,可靠性高,电功用好,全体本钱低一级特色。

2.BGA是什么–结构
PBGA—英文名称为Plasric BGA,载体为一般的印制板基材,一般为2~4层有机资料构成的多层板,芯片经过金属丝压焊方法衔接到载体上外表,塑料模压成形载体外表衔接有共晶焊料球阵列。
CBGA—英文名称为CeramicBGA,载体为多层陶瓷,芯片与陶瓷载体的衔接能够有两种方法:金属丝压焊;倒装芯片技能。具有电功用和热功用优秀以及杰出的密封性等长处。
CCGA—CCGA是CBGA尺度大于在32*32mm时的另一种方法,不同之处在于选用焊料柱替代焊料球。焊料柱选用共晶焊料衔接或直接浇注式固定在陶瓷底部。
TBGA—载体选用双金属层带,芯片衔接选用倒装技能完成。能够完成更轻更小封装;合适I/O数能够较多封装;有杰出的电功用;适于批量电子拼装;焊点可靠性高。

3.BGA是什么–分类
BGA是 1986年Motorola公司所开发的封装法,先期是以 BT有机板材制做成双面载板,替代传统的金属脚架对 IC进行封装。BGA最大的优点是脚距比起 QFP要宽松许多,现在许多QFP的脚距已紧缩到 12.5mil 乃至 9.8mil 之密距 ,使得PCB的制做与下流拼装都十分困难。但同功用的CPU若改成腹底全面方阵列脚的BGA方法时,其脚距可放松到 50 或60mil,大大舒缓了上下流的技能困难。现在BGA约可分五类,即:
(1)塑料载板(BT)的 P-BGA(有双面及多层),此类国内已开端量产。
(2)陶瓷载板的C-BGA
(3)以TAB方法封装的 T-BGA
(4)只比原芯片稍大一些的超小型m-BGA
(5)其它特别 BGA ,如 Kyocera 公司的 D-Bga (Dimpled) ,olin的M-BGA及 Prolinx公司的V-BGA等。
4.BGA是什么–处理
外层线路BGA处的制造:
可参照BGA规范、规划焊盘巨细对应客户所规划BGA方位做一个规范BGA阵列,再以其为基准将需校对的BGA及BGA下过孔进行拍正,拍过之后要与原未拍前备份的层次比照检查一下拍正前后的作用,假如BGA焊盘前后误差较大,则不可选用,只拍BGA下过孔的方位。
BGA阻焊制造:
首要BGA外表贴阻焊开窗:与阻焊优化值相同其单边开窗规模为1.25~3mil,阻焊距线条距离大于等于1.5mil;
然后BGA塞孔模板层及垫板层的处理:制做2MM层:以线路层BGA焊盘复制出为另一层2MM层并将其处理为2MM规模的方形体;制造塞孔层:以孔层碰2MM层,参数Mode选Touch,将BGA 2MM规模内需塞的孔复制到塞孔层;复制塞孔层为另一垫板层;按BGA塞孔文件调整塞孔层孔径和垫板层孔径。
其实因为电子信息产品的一日千里,PCB职业的剧烈竞赛,关于BGA塞孔的制造规程是经常在替换,并不断有新的打破。这每次的打破,使产品又上一个台阶,更习惯商场改变的要求。等待更优越的关于BGA塞孔或其它的工艺出炉。
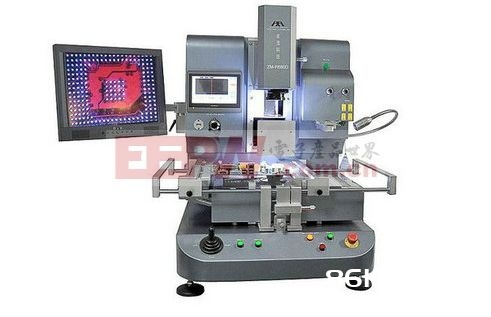
拓宽阅览:
1.BGA、TAB、零件、封装及Bonding制程术语解析
2.什么是盲埋孔?
3.用JTAG鸿沟扫描测验电路板、BGA和互连