今天,全球闻名终端品牌小米在北京工业大学体育馆举行新品发布会,小米2017年度旗舰机——小米6的奥秘面纱被揭开。这款备受等待、凝集小米公司探究精力的旗舰机被誉为“梦境之作”。小米6选用了来自汇顶科技(上证股票代码:603160)全球创始并具有自主知识产权的Invisible Fingerprint Sensor(IFS)指纹与触控一体化技能,完结了“一体化”前屏面板规划和前屏“无孔式”指纹认证,出现给终端用户宛如艺术品的高颜值和发烧级的用户体会。
IFS指纹辨认计划 为科技与艺术而生

小米6首发上市产品选用的IFS指纹辨认芯片由汇顶科技独家供给,体现了小米对汇顶科技产品立异性的认可、及对其专业服务与交给才能的信任,也体现了两边努力为顾客打造极致用户体会、矢志不渝带来推翻性立异产品的一起自愿。IFS指纹辨认计划现已取得多家国际闻名终端品牌客户的喜爱并完结了大规划商用,在产品功用和质量等方面能够满意客户与顾客的更高需求。
IFS技能是依据电容式指纹辨认原理,经过汇顶科技立异的芯片规划及图画算法,能够有用穿透手机触屏玻璃面板,完结精准快速的用户指纹特征获取、比对、认证的一项软硬件归纳立异技能。IFS指纹辨认模组能够直接贴合在触控屏玻璃面板下方,无需在手机正面或反面挖通孔,既便于终端厂商完美保存原有的外观规划风格,又能满意时下最盛行的窄边框规划,更能起到防水防尘的效果,终究完结更快捷的指纹辨认体会与更佳视觉享受。
开创性立异 复兴“我国芯”
智能终端商场的蓬勃开展与顾客对产品立异体会的更高寻求,使终端品牌厂商和工业链上下游的技能立异面对更多应战。汇顶科技一直坚持软硬件处理计划相结合的自主立异,悉心研究,在焦灼的职业竞赛布景下,打破技能瓶颈,完结了多项推翻式开创性的立异技能并成功商用,屡获国际国内大奖。截止2017年3月,汇顶科技已请求、取得国际国内专利共1200余件。近来,汇顶科技又凭仗其在2016年优异的商场体现荣获“2016年我国集成电路规划十大企业”的称谓。一起,IFS™指纹辨认计划也在2016年一举斩获了CES全球立异大奖,汇顶科技由此成为首个取得该项大奖的我国IC规划公司。
? 凭仗持续抢先的技能立异和广泛的全球终端客户商用,汇顶科技已开展成为全球指纹辨认范畴的技能立异领导者。作为安身我国,放眼全球的芯片规划公司,汇顶科技将持续以推进我国半导体工业开展为己任,持续强化研制投入并将技能立异效果规划商用,为全球的终端顾客带来更安全、更快捷、更智能的使用体会。
因而,在手机厂商出于防水、漂亮要求而努力于撤销Home键的布景下,盲孔电容式Under Glass计划有望在近期内成为指纹辨认的干流。
2016年12月,选用汇顶IFS技能的联想ZUK Edge手机发布。2017年2月,华为发布全新旗舰机P10,部分手机选用了汇顶的IFS技能,这表明盲孔电容式Under Glass指纹技能现已具有量产所需的老练度。
现在Under Glass计划的难点在于:首要玻璃自身十分软弱,假如挖槽,会下降整块玻璃的强度,加大玻璃加工的难度,这对康宁、AGC、肖特等玻璃原资料供货商和蓝思、伯恩、星星科技等玻璃加工商而言,具有必定的应战性;为了进步信号的信噪比,削减信号在塑封材猜中的丢失,芯片的封装需求选用先进的TSV技能(可有用减缩芯片厚度);盲孔的深度及平坦度公役很难操控,而选用TSV的指纹芯片需求直接与玻璃贴合,因而关于玻璃加工而言有较高的技能要求。
与此一起,依据现在干流的正面注册孔式计划的晋级产品——能够嵌入玻璃的“超薄式”正面玻璃/陶瓷盖板模组的指纹辨认,因为能够进步屏占比,本年也或许被一些旗舰机型选用,也是重要趋势之一。
选用“超薄式”正面玻璃/陶瓷盖板的指纹辨认模组,能够有用缩小整个模组的体积,尤其是厚度,然后使得整个模组的厚度不逾越盖板玻璃。这样的话,手机的显现屏幕便能够向下拓宽,与指纹Home键的间隔愈加严密(乃至能够掩盖Home键方位),然后大幅进步整个屏幕的屏占比。
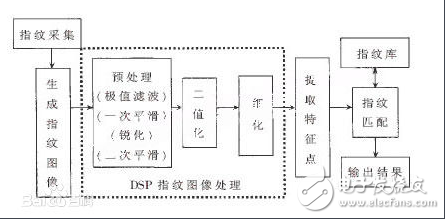
现在,该计划现已开端在多家手机厂商测验,有望成为本年的趋势之一。因为传统的wire bonding封装是难以有用减缩芯片厚度的,选用TSV封装能够处理该问题。
2TSV先进封装将成为指纹辨认工业链重构的重要受益者
2014年苹果iPhone5s搭载指纹辨认,首要选用的是“trench+ wire bonding(深坑+打线)”的工艺进行芯片级的封装。
事实上,选用wire bond(打线)的封装工艺需求进行塑封,这将使得芯片的厚度添加,关于寸土寸金的智能手机而言,尤其是在各大手机厂商竞相“求薄”的布景之下,wire bond并不是最佳计划。一起,虽然iPhone5s结合了trench+ RDL+ wire bond的封装工艺,来缩小芯片尺度,削减信号丢失,可是跟着更优的封装计划TSV的兴起,苹果在随后的iPhone6s和iPhone7中,决断将指纹辨认封装切换至TSV计划,由台积电供给封装服务。
好像SITRI对苹果iPhone7的指纹芯片拆解,选用TSV(硅通孔)封装技能之后,芯片的有用勘探面积大幅添加,芯片的厚度和模组厚度都完结了减缩。第一代Touch ID Sensor(iPhone5s/6选用)为88 x 88像素阵列,第二代Touch ID Sensor(iPhone6s/7选用)为96 x 112像素阵列,足足进步了近40%,像素的大幅进步带来辨认精度的进步。
事实上,苹果公司在指纹辨认范畴是走在最前列的,无论是第一代Touch ID Sensor选用的trench+wire bonding工艺,仍是第二代Touch ID选用的TSV工艺,在技能上都是十分先进的,都是十分紧缺的封装资源,当然本钱也十分高。关于除了苹果之外的手机厂商而言,无论是出于本钱方面的考虑,仍是资源方面的考虑,指纹辨认芯片封装选用TSV工艺的份额仍是十分少的,大多数厂商选用的是wire bonding工艺。
现在,大多数指纹辨认计划,芯片选用wire bonding工艺进行封装,技能老练,本钱低。因为外表需求与盖板资料贴合,因而在芯片的正面会进行塑封处理,将金属引线埋葬起来,构成平坦的外表。塑封的存在会影响信号辨认的精度,一起添加芯片的厚度,可是关于现在干流的开孔指纹方式来说,问题并不大,因为芯片+盖板资料(或CoaTIng)直接与手指触摸,依然能够完结较好的指纹辨认体会。
2016年以来,一些手机厂商开端向苹果学习,对指纹辨认芯片进行小规划的trench或TSV封装,如华为Mate9 Pro选用的是trench+TSV封装工艺(比直接TSV工艺简单一些)。因为先进封装直接的优点便是信号变强,指纹辨认精度体会更佳,更重要的是芯片厚度变薄,然后减缩指纹模组的高度,能够扩展屏占比。
选用“超薄式”正面玻璃/陶瓷盖板的指纹辨认模组,能够有用缩小整个模组的体积,尤其是厚度,然后使得整个模组的厚度不逾越盖板玻璃。这样的话,手机的显现屏幕便能够向下拓宽,与指纹Home键的间隔愈加严密(乃至能够掩盖Home键方位),然后大幅进步整个屏幕的屏占比。因为传统的wire bonding封装是难以有用减缩芯片厚度的,选用TSV封装能够处理该问题。因而,该计划本年也或许被一些旗舰机型选用,也是重要趋势之一。
该计划与现在干流的正面盖板开孔式计划在产品结构方面根本共同,最大的差异在于出于模组减薄的考虑,芯片的封装方式将由传统的wire bonding改为TSV封装,这将利好TSV封装工业。
依据咱们前文的剖析,电容式Under Glass计划将成为指纹辨认近期内的重要趋势之一,现在有两种计划——在盖板玻璃的正面或反面开盲孔。芯片是直接内置于盖板玻璃之下的,原本电容信号穿透玻璃就现已存在较大困难,假如还有塑封资料的话,信号质量将愈加堪忧。假如不选用塑封的话,wire bonding的键合线直接露出在外,会导致芯片正面不行平坦,是无法与盖板玻璃严密贴合的。因而,咱们以为,在电容式Under Glass计划大势所趋的布景之下,TSV封装将替代wire bonding成为必定之选。
跟着半导体工艺走到28纳米今后,缩小工艺尺度所带来的本钱下降曲线(功用上升)现已不能契合以往的斜率,现在来看,单纯缩小工艺尺度的办法的确难以维系摩尔定律,可是,连续摩尔定律并不是只要缩小工艺尺度一条路能够走。以立体封装为代表的先进封装技能就能够在不减缩工艺尺度的前提下,添加集成度然后进步功用下降本钱,所以这种技能道路也被称为新摩尔定律或许逾越摩尔(More than Moore)。
现在,先进封装技能是指第四代IC封装技能,包含SiP、WLP、TSV等技能,具有尺度缩小化、引脚密布化与体系集成化等特色。SiP(体系级封装)是指使用各种堆叠集成技能,将多个具有不同功用的芯片及被迫元件集成到尺度更小的封装元件上,构成一个体系,能够优化体系功用、防止重复封装、缩短开发周期、下降本钱、进步集成度;WLP(晶圆级封装)是在整片晶圆上进行封装和测验,然后才切割成一个个的IC颗粒,因而封装后的体积即同等IC裸晶的原尺度;TSV(硅通孔)技能在芯片间或晶圆间制作笔直通道,完结芯片间笔直互联,具有高密度集成、电功用进步、异质集成等优势。
因为先进封装在进步芯片功用方面展示的巨大优势,未来几年全球首要厂商都会在先进封装上持续投入。依据全球闻名咨询机构YOLE的猜测,从2015年到2020年,全球先进封装商场年复合增加率估计为7%。其间,对先进封装在我国的开展更为看好,增加可期的我国集成电路工业、全球在先进封装范畴的持续出资、愈演愈烈的半导体公司并购,以及我国政府的引导效果,将使我国先进封装商场的增速远大于国际均匀增速。猜测我国先进封装商场2015-2020年复合增加率为16%,2020年我国先进封装商场规划可达40亿美元(2015年商场规划约为20亿美元)。
TSV(硅通孔)技能作为3D封装范畴最中心最根本的技能,现已成为CIS图画传感器、高端存储器的首选互连处理计划。硅通孔技能还完结了逻辑电路与CMOS图画传感器、MEMS、传感器以及射频滤波器的异质集成。在不远的将来,硅通孔技能还将完结光子和LED的功用集成。
全球TSV工艺晶圆估计高增加。依据YOLE的猜测,到2020年3D和2.5D TSV互连技能商场估计将到达约200万块晶圆,复合年增加率将达17%。商场增加驱动力首要来自高端图形使用、高功用核算、网络和数据中心对3D存储器使用的需求增加,以及指纹辨认传感器、环境光传感器、射频滤波器和LED等新使用的快速开展。
现在,TSV技能的使用范畴首要会集在CIS(CMOS图画传感器)和MEMS产品,一起FPGA芯片、Memory存储器、指纹传感器、射频芯片等范畴也逐步开端使用。尤其是在CIS范畴,TSV能够大幅减缩芯片尺度,关于寸土寸金的智能手机而言极端要害。例如,CMOS图画传感器的领导厂商索尼,经过full-filled TSV和via last办法来完结图画传感器与CMOS芯片堆叠,使得芯片外表的面积使用率进步(90%),减小芯片尺度。这项技能称为Exmor,选用3D堆叠集成办法,这现已成为趋势。
2晶方科技指纹辨认TSV封装事务将迸发
2013年9月苹果iPhone5s搭载指纹辨认,首要选用的是“trench+ wire bonding(深坑+打线)”的工艺进行芯片级的封装。苹果iPhone5s的指纹辨认做trench+RDL的工艺在台湾精材和姑苏晶方进行,芯片做完RDL后,再由日月光完结wire bonding以及SiP模组的制作。2014年苹果推出的iPhone6持续选用与5s共同的芯片封装技能
晶方科技现已开宣布了国际上第一个ETIM™ (Edge Trench Interconnect Module) 技能。ETIM™ 计划包含晶圆级互连办法、先进的模块制作等很多先进的传感器封装相关的技能,能够说是现在最先进的指纹传感器模块技能之一。ETIM™处理计划能够完结更小的外形、杰出的可靠性、超卓的传感器功用和功用,能够创造出比以往更薄和更先进的电子产品。
汇顶科技现已开展成为全球人机交互及生物辨认技能领导者,晶方科技是汇顶科技重要合作伙伴。汇顶科技于2014年第四季度进军指纹辨认范畴,在短短三年内,敏捷卡位商场,在非苹果系的智能手机范畴,市占仅次于FPC,位居第二。在切入指纹辨认初期,就推出了指纹传感器技能、指纹匹配算法两项中心技能,并使用这两项技能研制出业界抢先的指纹芯片产品GF9系列,首要使用于智能手机等终端。推出了商场抢先的全系列指纹芯片产品,并成功使用于中兴、乐视、魅族、VIVO、金立等闻名品牌手机客户。在指纹芯片的封装方面,具有先进封装技能和丰厚经历的晶方科技,成为了汇顶科技重要的合作伙伴。









