柔性电路板上倒装芯片拼装技能解析
由思想来操控机器的才能是人们长久以来的愿望;特别是为了瘫痪的那些人。近年来,工艺的前进加快了人脑机器界面( BMI )的开展。针对生物医学的运用,杜克大学的研讨者现已成功地运用神经探针开宣布信号处理的ASIC,以及无线传输动力与信息的电子电路系统。再下一步,便是开发组件的封装技能。 可是,这些组件将怎么彼此联接呢?
尺度和牢靠性对生物医学用的植入物而言,是最重要的两个要素。 微电子业的两个封装技能(倒装芯片接合和柔性载板)正好适用于这个运用。倒装芯片接合技能现已开展30多年了。此一技能的长处是体积小、接线密度高,而且因为引脚短而电性得以改进4。倒装芯片接合技能的另一个优势,是能够将多个不同尺度的芯片封装在同一片载板上,构成多芯片模块。这种封装办法能革除又大又不牢靠的连接器。
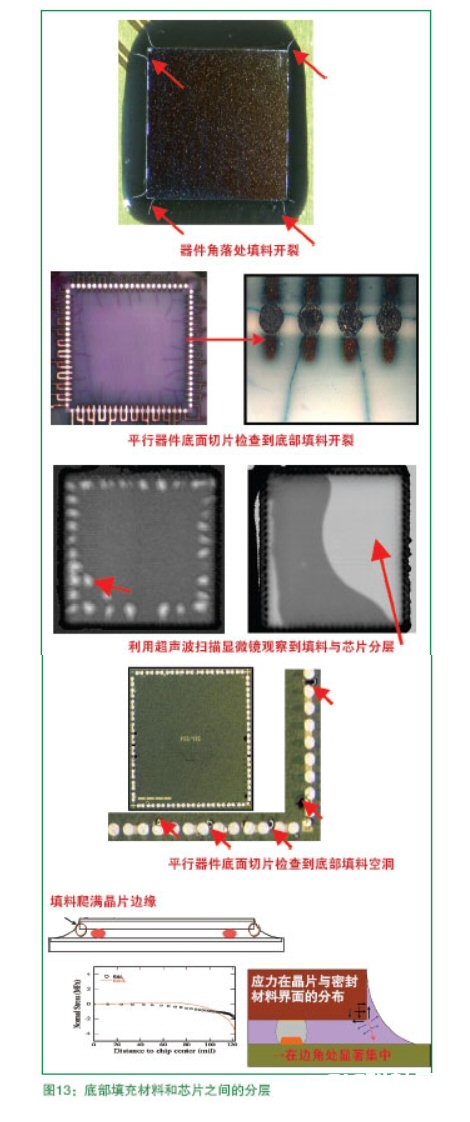
此外,由聚亚酰胺(polyimide)做成的柔性载板能够曲折和折迭,能够充分运用空间做成体积小的组件。但因为聚亚酰胺资料仅适用于低温接合技能(制程温度低于摄氏200度),所以有必要运用热硬化黏胶,而非焊锡来供给机械性和电性的联合。在这个研讨中,咱们运用低成本的柱形金凸块技能,而非其它相似运用中所选用的锡铅凸块技能。
为了开展适用于生物医学运用的制程,咱们规划并以聚亚酰胺为基材制作测验芯片。这些测验芯片在打上柱形金凸块后,被用来验证制程。咱们别离测验了导电和绝缘的热硬化黏胶,并在做过温度循环测验后,丈量触摸电阻以评量产品的牢靠性。
接合技能
咱们期望能够运用柱形金凸块技能和热硬化黏胶,开展一个牢靠的制程,将切开后的芯片接合在柔性载板上。在这个研讨中,咱们测验了两个接合的办法;第一个办法运用绝缘的热硬化黏胶、第二个办法运用导电黏胶和绝缘的底部填充胶。每一个测验组件都由测验电路载板和仿真芯片(dummychip)所组成。管脚阵列封装的载板也被规划在同一片聚亚酰胺载板上,以便于未来用于测验神经信号放大器芯片。

仿真芯片的制备:为了使软性的仿真芯片能像硅芯片相同硬,咱们得在这个软性的仿真芯片背部加上一个加强性构件。可是由载板制作商供给的加强性构件太软了,所以咱们用一小块1毫米厚的显微镜用的载玻片替代制作商所供给的加强性构件。柱形金凸块:测验中所运用的仿真芯片和芯片的柱形金凸块都是用手动金球焊线机(Kulicke & Soffa抯 4524AD)做出来的。
绝缘的热硬化黏胶接合:在绝缘的热硬化黏胶接合办法中,长了柱形金凸块的芯片和载板用绝缘的热硬化黏胶接合。芯片和载板的对准和接合是用倒装芯片接合机(SUSS Microtec抯 FC150)。接合的过程如下:
1.将长了柱形金凸块的芯片和载板装载到倒装芯片接合机。
2.芯片和载板由倒装芯片接合机对准。
3.将绝缘的热硬化黏胶涂布在载板上。
4.依表2与图3的条件将芯片与载板接合。
5.黏胶在接合的压力下被热硬化, 然后在释压前冷却下来。
导电黏胶的接合技能
在导电黏胶的接合办法中, 先将长好柱形金凸块的芯片放入银胶的薄层。 再把这个沾了银胶的芯片用绝缘的热硬化黏胶与载板接合。芯片和载板的对准和接合也是运用倒装芯片接合机。接合的过程如下:
1. 将长了柱形金凸块的芯片装载到倒装芯片接合机。
2. 将载玻片放在放载板的吸盘上。
3. 将薄薄的一层导电银胶在涂布在载玻片上。 留意: 将导电银胶稀释10%以达到较好的沾胶作用。
4. 用倒装芯片接合机将导电银胶延展成30 微米厚。
5. 将长了柱形金凸块的芯片压入30 微米厚的导电银胶层。
6. 取走载玻片,然后放入载板。
7. 在载板上涂布绝缘的热硬化黏胶。
8. 将芯片与载板对准,然后透过黏胶与载板接合。
9. 黏胶在接合的压力被热硬化, 然后在释压前冷却下来。
温度循环测验:温度循环测验经常被用来验证接合点的牢靠度。在温度循环测验期间,每30秒就记载一次温度和仿真芯片上一对凸块间的电阻。
温度循环测验的温度改变条件设定如下:
1. 保持在摄氏85度,10 分钟。
2. 以最快的速度降温到摄氏零下10度 。
3. 保持在摄氏零下10度,10 分钟。
4. 以最快的速度升温到摄氏85度。
5. 重复这个温度改变周期 。
将仿真芯片从聚亚酰胺基材上切开下来,黏合载玻片以加强软性仿真芯片的结构强度,打上柱形金凸块,然后以前述的两种办法(绝缘的热硬化黏胶接合技能、导电的热硬化黏胶接合技能)将仿真芯片与柔性载板接合起来。因为这个做在聚亚酰胺基材上的仿真芯片是半透明的,咱们能够以目检检视接合的界面。柱形金凸块看起来是很均匀的被紧缩,这表明平面度操控得很好。对准的精确度操控在 3 微米之内。能够看到在黏胶层之内有一些空气气泡,可是,这些空气气泡看来并不会影响效能。
运用柱形金凸块和黏胶的接合技能有几个长处。首要,这个办法适用于已切开的芯片。 实践上,运用软性的仿真芯片作为测验组件,是一个开展接合技能的较廉价且实践的办法。而半透明的测验组件更是运用聚亚酰胺做为基材时所未预料到优点。 因为测验组件是半透明的,咱们能够容易的运用光学微镜来查看接合的质量。运用绝缘的热硬化黏胶接合技能,制程过程较为简略,而且不需求清洗过程与额定的底部填充胶。在导电黏胶的接合办法中有几个过程需求十分当心的操控,特别是涂布银胶与沾胶。此外,为了机械强度的考虑,需求增加涂底部填充胶的过程。这两个办法的共通缺陷便是黏胶固化时刻(10分钟)太长;就研讨而言,这是可接受的。可是,就量产而言,一种固化时刻更短的黏胶是有必要的。咱们信任黏胶和底部填充胶被固化时,能将芯片和载板拉紧,因此强化了接合的质量。在温度循环测验中, 绝缘的热硬化黏胶接合技能的均匀电阻,契合咱们的预期;这个成果也和其它单位的成果适当。运用绝缘的热硬化黏胶接合技能,在柔性载板做倒装芯片接合所制备的组件与商业化出产的陶瓷管脚阵列封装组件,在电性上的表现是共同的。 此外, 此一技能还有体积小与能适用于不同形状的优势 。
为了以倒装芯片封装将神经信号放大器的ASICS芯片接合上柔性载板,咱们开发并评价了两种接合办法,并用制作于聚亚酰胺基材上的仿真芯片做制程的开发与测验。根据制程简略与牢靠性佳的考虑,咱们选用绝缘的热硬化黏胶接合技能与柱形金凸块技能。咱们也用这个办法将神经信号放大器的ASICS芯片接合上管脚阵列封装载板。第一个试做就产出了一个 100% 功用杰出的产品。