半加成法SAP于载板之量产
当线宽线距小于50μm(2mil)者,传统CCL的减成法几已无用武之地。而现在CSP或FC覆晶等载板的Line/Width已迫临到了15μm/15μm,关于大排板之量产而言,只能选用无铜箔披覆(Copper Claded)的绝缘板材做为SAP(Semi-AddiTIve Process)半加成法的起步。下列者为已量产之FC产品与连环图示之SAP流程,并在后文中阐明各制程站的作用及关键。
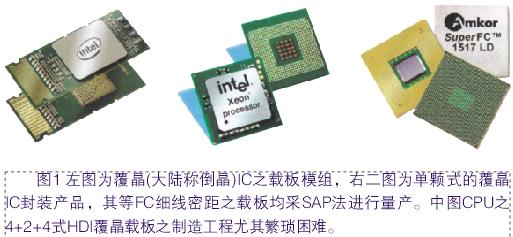
Inner layer ABF laminaTIon
ABF laminaTIon Laser drill
Laser drill Electroless CU Seed layer
Electroless CU Seed layer Photo resist patterning
Photo resist patterning ElectrolyTIc Cu plaTIng
ElectrolyTIc Cu plaTIng Photo resist removal
Photo resist removal Seed layer etching
Seed layer etching
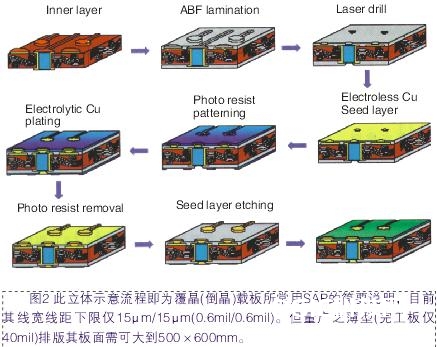
1.1 ABF绝缘薄材的真空压膜
1.1.1ABF薄材之结构
在已完结线路及黑氧化处理之大型双面(或四层)内层薄芯板(Core厚度2.5mil)上,双面一起真空压贴上白色无铜却备有聚酯护膜(Mylar,Polyester)的B-Stage ABF薄膜板材,随后还需在180℃中持续硬化30分钟。此ABF(Ajinomoto Bond Film)为日商“大运味之素”旗下“味之素精细技能”公司(AFT)的高价板材,其现行产品有三种:
①一般型SH9K(Tg165℃,TMA)
②无卤型GX-3(Tg153℃)
③无卤低Z胀大型GX-13(Tg156℃),其а2之Z胀大仅155ppm/℃罢了。
留意,味之素精细技能(AFT)公司不光在载板范畴推出共同的ABF产品,并且在软板业界也还有ABF-XA5之2L式基材与ABF-LE-T的3L式基材应市。

1.1.2真空压膜
首要按传统多层板之制程先竣工内层芯板,再进行树脂孔与全板面的完全削平,以便利ABF薄材的双面贴合。依据Ajinomoto Fine Techno(AFT)网站上的材料,系将主动裁膜机所切开有如干膜式的ABF三层材,再使用抽真空式主动贴膜机,先在内层芯板双面贴上已撕掉阻隔膜的ABF双层材。该接连式真空贴膜的温度约110℃时刻约30秒,之后还要再使用热压床在110℃与5kgf/cm2的高压中历经60秒的压平与固化。随后即可撕掉Mylar(PET)的通明维护膜,并持续所贴ABF膜材的后硬化工程。以GX13为例,还需在180℃中又经30分钟的熟化(Cure)才算增层之竣工。
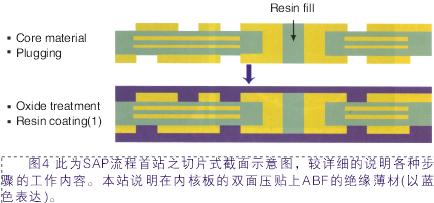

1.2 雷射成孔及全板面式除胶渣
ABF熟化后的膜厚约在30~70μm之间,薄板者以30~40μm较常用一般双面CO2雷射竣工的2~4mil烧孔,其孔形都可出现杰出的倒锥状。无铜面之全板除胶渣(Desmearing)后,其全板面与孔壁均可构成极为粗糙的外观,化学铜之后对细线路干膜的附着力将有协助。

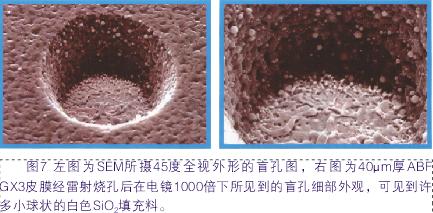
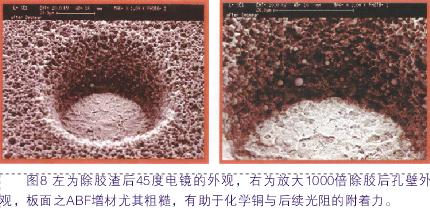
覆晶载板除胶渣的动作与一般PCB并无太大差异,仍然是预先膨松(Swelling)、七价锰(Mn+7)溶胶与中和复原(Reducing)等三站。不同者是一般PCB只处理通孔或盲孔的孔壁区域,但覆晶载板除了盲孔之孔壁外,还要对全板的ABF外表进行全体性的膨松咬蚀,为的是让1μm厚的化铜层(已较一般PCB厚了一倍以上)在外观上更形粗糙,而令干膜光阻与电镀铜在大面积细线作业中获得更好的附着力。
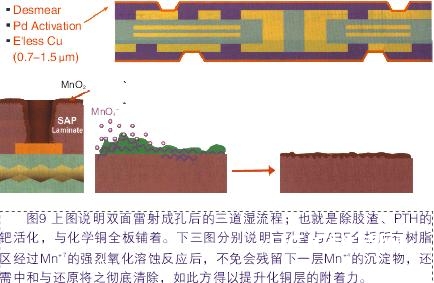
1.2.1SAP半加成法除胶渣之差异
一般多层板的除胶渣仅仅针对PTH或μ-Via等孔壁而做,处理的总面积并不算大。但SAP法却不光处理微盲孔壁,并且还一起要对两外表无铜的大板面进行反响。两者间之巨大差异当然不能选用同一规范现场办理。有必要改动的榜首要件便是对Mn+6的及时电解氧化以保持槽液的最少作用;其二是怎么铲除高温槽液中已遭复原的Mn+4沉淀物;其三是怎么扫除强碱槽液反响生成CO2从而累积的Na2CO3。现在尚无杰出方法处理Mn+4和Na2CO3等固形物问题,只能按处理的总面积而倒掉部分槽液。当然也还要参阅槽液的比重以控制Na2CO3的总量,以决议是否需求更换新槽。由是可知SAP此站本钱之高绝非一般PCB除胶渣之可比。
1.2.2除胶渣后还要咬掉球状无机Filler以添加化铜层的附着力
ABF膜材的除胶渣与硬板别的不同者,是中和复原之后还要加做一道咬脱SiO2或玻璃小珠等填充料(Fillers)的工序,以加大外表积保证后续化铜层的抓地力。缺陷是板材死角大幅增多下,导致后来蚀刻咬掉化铜层构成独立线路之际活化用的贵金属钯层却仍然会残留在板材中,埋下细密线路间绝缘不良的隐忧。尤其是外层板面只要一层薄薄的绿漆维护下,高温高湿环境长时间工作中难免不保出现绝缘失效,乃至引发信号完整性欠安的问题。
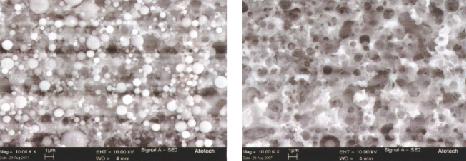
图10.此二图为SEM在1万倍下的画面,左为除胶渣后ABF的外表外观,右为再持续咬蚀SiO2拉掉小球出现小圆坑的画面,如此将对化学铜层供给更好的抓地力而有助于干膜光阻的附着。
1.3 光阻成像前的低应力化学铜
ABF外表完结2μm化学铜之后即可进行干膜光阻的压贴,随后进行曝光与显像而获得很多线路与很多盲孔(18×24”排板的双面常在80万盲孔以上)的镀铜基地,以便进行线路镀铜与盲孔填铜。此处之电镀铜即等于一般PCB的二次铜,而化学铜层则有如一般PCB在CCL铜箔上所添加的化铜与一次铜。
由此可知SAP法的化学铜所扮演的人物要比一般PCB的化学铜更为吃重,其厚度方面也要求添加到1!1.5μm至少是惯例的两倍以上。为了要获得更好的附着力起见,此处的化铜层还非常考究结晶变大与应力下降的晋级版别;不光出产速率要变慢(连惯例化铜的一半都不到),并且CP级的各种化学品更使得本钱上升3倍以上。一般HDI多层板现已负担不起,只要FC载板还能勉为其难的选用此种高级高单价的低应力化学铜。
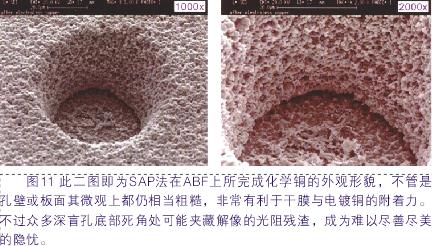
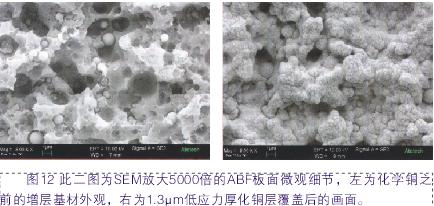
1.4 干膜成像后的电镀铜
SAP所用的电镀铜与一般HDI填充盲孔者并无不同,均属纵横比较低非深孔性的高速镀铜。换句话说便是不大考究延伸率(Elongation)与抗拉强度(Tensile Strength)的短孔镀铜。在屡次增层填充盲孔的ELIC主导市场下,此等屡次高速镀铜最主要的诉求便是“快”。但在酸性镀铜极限电流密度(Limited Current Density,Jlim)的天然生成妨碍下,底子无法拉高电压提高电流,只要尽量迫临铜槽中阴阳极之间隔(笔直挂镀已由本来的20cm拉近到5~10cm,水平走镀更迫临到2cm),以下降铜游子的电阻从而到达提高可用电流密度之上的。一起也借由升高槽液温度(由20℃到40℃)以下降电阻与拉高电流。但如此一来将不能持续运用可溶性的铜球,以保持阴阳极间间隔的稳定,所以钛纲类非溶阳极乃大行其道于填孔镀铜的范畴中。然而非溶解阳极发作氧气的种种祸患,特别是有机添加剂的裂解与超用,其间尤以用量最多的载运剂为甚。所以槽液致命伤的有机总碳量(Total Organic Compound,TOC)乃节节攀高,为了保持镀铜的最少质量,又不得不守时倒掉部分槽液(每周倒掉1/10槽液),只弥补DI水以按捺TOC的不断上升。至于钛纲阳极的快速耗费与氧化铜的弥补又成为另两项本钱的负面要素。传统深孔的缓慢镀铜与新式盲孔的快速填铜,其互相间的是是非非与好坏良窳,则端看是从哪一种态度去考虑了。

1.5 咬掉部份化铜后完结线路
完结填充盲孔与增厚线路的镀铜工序后,即可剥除光阻而直接进行全面性蚀该。此刻板面上非线路绝缘区的化学铜很简单蚀除,所以在不分青红皂白全面铳蚀下,线路的镀铜当然也会有所消磨但还不致伤及大雅。所出现的细线不光肩部更为油滑连底部剩余的残足也都消失无踪,质量反倒更好!此等天公地道通面全咬的蚀该法特称为Differential Etching。

图14.此六图均为SAP 3+2+3大版面量产薄板(总厚40mil)之切片图;左上为1mil细线与内核板之50倍全体画面。中上为200倍明场偏光画面,可见到核板被陶瓷刷轮当心真实削平与三次ABF之增层。右上为暗场1000倍的出现,其黑化层清楚可见。左下为1000倍惯例画面,可清楚见到有铜箔之核板其线路边际之向外斜伸与ABF板材在SAP增层之直立线边互相有所不同。中下为200倍的暗场真像,可见到核板玻纤胶片与三层ABF薄材以及外层的绿漆,还可窥得各增层独立线路间ABF上的深色细影,那正是挥之不去留下后患的活化钯层了。右下为3000倍ABF增一层的暗场画面,底垫为1/3oz铜箔与厚电镀铜,铜箔底部之黄铜层以及盲孔左右之活化钯层与化铜层均清晰可见。
二、相邻OSP垫面的异色
OSP处理过的各种板类,经常在某些电容器的两头垫上出现深浅不同的棕色差异,通过焊锡性实验与下流客户的实地量产,均未发作任何焊点不良的问题。但锲而不舍的客户仍是穷追猛打,不断要求真因与改进。PCB业者也会想尽各种招数乃至还追查到药水供货商去,在历来无解下难免也置疑到是否规划与布局(Layout)方面出了什么问题,想要把皮球踢回客户端以求脱困。然而在苦无依据下,也只好百般无奈的认错抱歉与理赔以求排难解纷。
2.1 外观与扩大存证
笔者最近又曾碰到了相同的事例,经多方深化刨根究底下,总算将疑团解开而自认已获得了本相,以下将采图解方法逐个阐明此等好像残次的发作原理。

图15.从左二图红标贴纸可见到分属两电容器焊垫的中垫色彩特别深,与上两个色彩较浅者构成激烈的比照。右二图从另一片相同料号板子的同一方位处也见到色差很大的现象,可见此等异色现象并非独自事情而是整批性的问题。
2.2 微切片调查
为了弄清楚三个相邻异色的本相,首要即对该方位进行切片调查,下图15即为三垫的剖面景象及其于全板布局的联系方位,并由图14可知此三垫均座落于某十层板的第十层外表(L10)。中心色彩较深者是L10的独立垫,左右两边垫则各有盲孔镀铜互连到L9,且还持续向内连到L8以及其他各内层去(已超出画面规模以外了)。

图16.上图扩大200倍阐明三垫居全板L10之方位,下三图扩大500倍下清楚见到两边有盲孔铜垫所镀的三次铜,两边淡色垫之面铜层明显已较中心独立深色垫者被咬得更多一些。
2.3 咬铜多少比较的数量化
为了再进一步了解三垫电镀铜层在OSP流程中,各被咬掉多少而在厚度方面有所差异起,乃故意使用显微镜之软体量测三垫铜厚以做为比照。从下三切片图之数字阐明看来明显是中心深色独立垫者被咬的最少,而两边淡色互连垫中又以直接使用2个叠盲孔内连到L8者被咬得最多。

除了此等微切片软体测厚外,还可使用WyCo的精细粗糙衡量测仪,对所标明的两种铜垫针对极材外表进行精细量测,以再次佐证推论的正确性。由所得数据可知独立深色垫之均匀铜高为29.1μm,而互连盲孔淡色垫之均匀铜高为25.3μm。留意下二图中蓝色表明最低位的板材外表,草绿色者为铜垫高度,外缘赤色者则为更高的绿漆。(见图18)

2.4 OSP皮膜的生成
洁净铜面在甲酸或乙酸装备的OSP槽液中首要被溶出成Cu+1,而此一价铜离子将马上与药水中的有机物咪唑(Imidazole)络合(错合)成为棕色的有机皮膜而逐渐增厚。上述有盲孔的淡色铜垫因为咬铜又快又猛,导致其部份一价铜会快速被氧化成蓝色的二价铜而进入槽液而不再成膜,致使其构成皮膜的厚度比起独立垫来难免相形见拙,因而就出现深色与淡色的激烈比照了。(见右图所示)

文章摘自《印制电路资讯》09年11月第6期