导言
SOI技能带来器材和电路功能进步的一起也不行避免地带来了晦气的影响,其间最大的问题在于部分耗尽SOI器材的浮体效应。当器材顶层Si膜的厚度大于最大耗尽层的宽度时,因为结构中氧化埋层的阻隔作用,器材敞开后一部分没有被耗尽的si膜将处于电学浮空的状况,这种浮体结构会给器材特性带来显着的影响,称之为浮体效应。浮体效应会发生kink效应、漏击穿电压下降、失常亚阈值斜率等浮体效应。
因为浮体效应对器材功能带来晦气的影响,怎么按捺浮体效应的研讨,一直是SOI器材研讨的热门。针对浮体效应的处理办法分为两类,一类是选用体触摸办法使堆集的空穴得到开释,一类是从工艺的视点动身采纳源漏工程或衬底工程减轻浮体效应。所谓体触摸,便是使埋氧层上方、Si膜底部处于电学浮空状况的中性区域和外部相触摸,导致空穴不行能在该区域堆集,因而这种结构能够成功地战胜MOSFET中的浮体效应。
人们采纳了许多办法来按捺浮体效应,比较常用的如图1所示,有T型栅、H型栅和BTS结构。但T型栅、H型栅技能因为p型Si区体电阻的存在而不能有用按捺浮体效应,而且沟道越宽体电阻越大,浮体效应越显着。BTS结构直接在源区构成p+区,其缺陷是源漏不对称,使得源漏无法交换,有用沟道宽度减小。而且,源端的触摸引进了较大的寄生电容,使得器材功能变差。
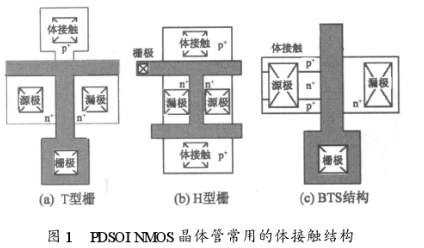
1、新结构的提出
如图2所示,本文提出了一种新的体触摸技能,该办法使用部分SIMOX技能,在晶体管的源、漏下方构成离Si外表较近的薄氧化层,选用源漏的浅结分散,构成侧向体引出结构。未在此基础上,恰当加大了Si膜厚度来减小体引出电阻,与以往办法比较,该办法具有较小的体-源、体-漏寄生电容,彻底消除了背栅效应、体引出电阻随器材宽度增大而减小,体电阻能够随Si膜厚度的加大而减小,且不以增大寄生电容为价值等长处。因而,该器材能更有用地按捺浮体效应。而且,为构成部分埋氧层,该办法仅仅在工艺上添加了一块掩模版,其他的工艺流程跟规范的SOI CMOS工艺共同,因而该办法具有很好的工艺兼容性。

该结构能够使用低能量、低剂量部分SIMOX技能完成,为了在器材的沟道下方不构成BOX层,在氧离子注入时,使用Si02掩膜进行掩盖,掩膜选用RIE(reactive ion etching),依据构成的部分埋氧层的深度和厚度确认注入的能量和计量,注入完成后,在Ar+0.5%O2的气氛中进行高温退火数小时构成部分埋氧层。Y.M.Dong和P.He等人的试验成果验证了部分SIMOX技能在工艺上的可完成性,使用透射电子显微镜对样品的微结构进行调查,其源、漏下方的BOX层十分完好,BOX层的端口与多晶Si栅相对齐,距离稍微大于栅的长度。整个单晶Si的外表十分平坦,源漏区没有因为构成BOX层而举高,也没有在退火过程中遭到氧化而下降。表l为新式结构器材的首要工艺参数,其间:Tox为栅氧厚度;TSi为Si膜厚度;Tbox为埋氧层厚度;Tsdbox为源漏下埋氧层厚度;Nch为沟道掺杂浓度;Nsub为衬底掺杂浓度;Ldrawn为沟道长度;Wdrawn为沟道宽度;Xj为源漏结深。
2、模仿成果与评论
选用ISE—TCAD模仿器对器材进行模仿并评论模仿成果。体触摸可在必定程度上按捺浮体效应。体触摸的作用还与触摸方位、器材的尺度和工艺有关。假如体触摸作用欠好,漏结磕碰电离发生的空穴依然会在体区堆集,使得当区空穴浓度增大,体区电位升高,阈值电压下降,因而漏电流增大。图3为浮体器材、T型栅体触摸结构和本文提出的新式体触摸结构的输出特性、切线处空穴浓度和器材的搬运特性曲线,三种结构工艺条件相同。由图3可见,本文提出的结构体区空穴浓度最低、阈值电压最高、没有kink效应发生,成功的按捺了浮体效应的发生。


图4是T型栅触摸和新式体触摸结构的输出特性随器材宽度改动状况比照。从图中能够清楚地发现T型栅在器材宽度较大时,漏电流特性改动愈加剧烈,kink效应显着,而新结构没有呈现kink效应。这是因为跟着器材宽度的添加,H型栅体引出电阻增大,kink效应的触发电压逐步下降。而新结构选用的侧向体引出结构,该结构的体电阻随器材宽度添加而减小。因而,在器材宽度较大时,该结构按捺浮体效应的作用显着。

由此可见,器材的体引出电阻的巨细对浮体效应的影响是至关重要的,为了有用按捺浮体效应,较小的器材体电阻是很必要的。C.F.Edwards等人报导了体触摸电阻的一级近似计算公式

式中:Weff为有用沟道宽度;Leff为有用沟道长度;NA为沟道掺杂浓度;up为载流子迁移率;TSi为Si膜厚度;ε0和εSi分别为真空介电常数和相对介电常数。由式(1)可知,体电阻Rb跟Si膜厚TSi成反比,加大Si膜厚度能够下降体电阻。可是,一般SOI器材的源端和漏端都是分散到埋氧层的,增大Si膜厚度会使器材源端和漏端与体区的触摸面积增大,致使体寄生电容增大,然后影响器材功能,寄生电容的增大也会延伸体放电的时刻,晦气于按捺浮体效应,而且,较大的源漏结深或许引起穿通效应。
本文提出的体触摸结构能够处理这一对立。该结构在源漏下面用低能量、低剂量注氧退火生成的部分氧化层,选用源漏浅结分散,源漏区面积小,体区寄生电容比较小,而且寄生电容不会跟着Si膜厚度的添加而添加。图5是膜厚度对体区空穴引出速度RbCb的影响。从图中能够看到,跟着器材厚度的添加H型栅的RbCb延时趋于饱满,而新结构的延时跟着Si膜厚度的添加而减小。这和方才剖析的成果相符合。阐明跟着器材宽度添加,H型栅结构的体电阻Rb减小,但与此一起,体电容Cb增大,在而且Cb添加的起伏和风减小的起伏共同,然后使得RbCb趋于饱满。而关于新体触摸结构而言,电阻Rb随Si膜厚度添加而减小的一起,体电容Cb并不改动,因而,RbCb随Si膜加大而逐步减小。以上的评论成果阐明,该结构能够在不添加寄生电容为价值的状况下,经过恰当的添加Si膜厚度的办法来减小体引出电阻,然后更好地按捺浮体效应。需求留意的是,假如这种器材Si膜比较薄,因为选用侧向体引出结构,结深和部分埋氧层所占的空间导致体引出通道较窄,导致体电阻变大,这是不期望看到的,因而实践应用时,新结构器材的Si膜厚度必需足够大,试验数据标明,250 nm Si膜厚度的新结构器材和200 nm Si膜厚度的惯例器材的体电阻巨细恰当,这阐明在其他工艺参数相同的状况下,新结构器材的Si膜厚度要大于250 nm的状况下,其优势才会显着。别的,在Si膜较厚的状况下能够考虑用逆向掺杂技能使体区杂质浓度加大,进一步减小体电阻。这就要考虑工艺对浮体效应的影响,超出本文的评论规模。关于工艺对浮体效应的影响将在今后做进一步研讨。

3、 定论
本文提出了一种体触摸结构,与其他体触摸技能比较,该办法的体引出电阻小,寄生电容小,体引出作用不受器材宽度的影响。而且能够在不添加寄生电容为价值的状况下,经过恰当的添加Si膜厚度的办法减小体引出电阻,然后更好地按捺浮体效应。别的,因为源和漏的浅结分散,没有到达SOI的BOX层,不会构成背栅敞开的沟道,因而,该结构不存在背栅效应。
责任编辑:gt