摘要 归纳化模块拼装密度高,热规划计划好坏直接影响模块各项功用指标。选用仿真手法比照优化计划,确认能添加导热通路的夹层结构。测验模块温升途径,经过在模块插槽鹊媛敛及在芯片与壳体之间加垫导热垫的办法下降触摸热阻,保证了热规划计划能满意模块功用要求,为相似模块热规划供给了参阅。
模块是电子设备的根本组成部件,跟着电子技术的展开,模块功用、运算速度、与之对应的功耗、热量、暖流密度得到不断增强。统计资料标明,电子元器材温度每升高2℃,可靠性下降10%,温升50℃时的寿数只要温升25℃时的1/6。因而温度是影响设备可靠性的重要要素。
面临高功耗、小体积、轻分量的要求,电子模块需选用更有用地散热结构,选用功用更优异的散热资料,进步传热功率,保证芯片在可接受的温度范围内作业,并满意运用环境要求且具有较高的可靠性。这就需求展开模块热规划方面的高密度拼装技术研究。
1 模块规划流程及要求
模块结构规划在电器体系架构、功用区分完结后开端。首要清晰功耗、温度、振荡、冲击等结构相关技术指标要求,确认开始结构计划。接着供给结构计划图给电气进行EDA预布局,针对预布局成果展开热、强度等相关仿真,并依据仿真定论对EDA布局及模块结构进行调整,对结构规划要素进行优化改进,几轮迭代后,完结模块结构计划规划。重要模块还需进行样件研发,对样件进行相关热测验及仿真比照,一起依据比对成果对样件再进行优化,完结模块结构规划。
一种契合SEM-D规范的处理器模块,外形尺度≤149.4 mm×122.7 mm×24 mm,常温功耗≤50 W,要求在-55~+70 ℃的环境下长期作业。处理器模块由主、从模块组成,主、从模块经过板间衔接器完成信号互联,处理模块经过LRM衔接器完成对外的电气衔接。主、从模块双面安置元器材,首要选用表贴器材,主、从模块功耗挨近,其均为20~25 W。
2 某模块结构计划规划
处理器模块体积小、功耗高、热环境恶劣,热规划准则要求将高功耗器材尽量分散开,并尽量挨近热沉的方位。因模块厚度尺度约束,板件衔接器高度最大可挑选7 mm,考虑器材高度及导热界面资料装置空间,主、从模块缝隙空间供给散热才能比壳体和盖板小,从距热沉远近考虑,器材应尽量挨近模块盒体,所以主、从模块的主散热面坐落板间衔接器不和,与壳体触摸。
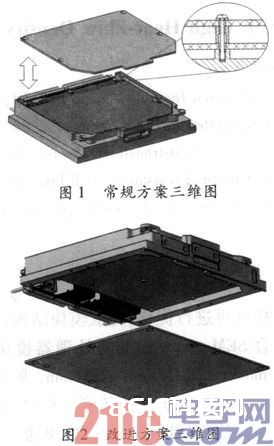
惯例计划挑选上侧开盖,如图1所示。长处为印制板布板面积较大,相对其他计划较为老练,缺陷是上盖板与盒体之间触摸面积小,触摸热阻大,主模块散热途径较长,散热作用差。改进计划是下侧开盖,如图2所示,盖板与盒体触摸面积大,热阻较小,主、从模块散热作用适当。两种计划首要不同在于盖板方位不同导致的触摸热阻差异。从热阻触摸公式中可看出,名义触摸面积与热阻巨细直接相关。
式(1)中R为触摸热阻;为两个触摸面的温度差;Q为经过界面暖流;A为界面名义触摸面积。依照经验值对触摸界面赋热阻值进行仿真,成果标明,改进计划中CPU芯片温度比惯例计划低2~3℃。一起将改进计划中主、从模块间垫柱改为一体隔板,添加散热通路,CPU芯片温度要比改进前低1~2℃,且便于修理,故确认改进计划为终究计划。

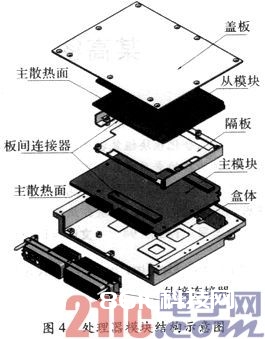
模块散热途径如图3所示,详细结构如图4所示。主、从模块发热元器材经过柔性导热资料与盒体、盖板触摸,中心隔板为主、从模块供给装置支撑的一起,经过柔性导热资料与主、从模块内侧非首要散热器材触摸,隔板两边挨近锁紧条边伸出立耳与盒体触摸,模块两边翼耳经过锁紧条与插槽衔接。盖板、隔板和盒体触摸面涂覆导热资料,以下降界面热阻。一切热量终究经过模块两边翼耳传导至机箱热沉。测验发现添加隔板散热通路,可使芯片温度下降2~3℃,主、从模块CPU芯片温差一直操控在1℃以内,标明主、从模块散热通路热阻均衡,仿真与实践成果相一致,阐明改进有用。
3 测验优化
将处理模块刺进测验机箱,按模块传热途径散布传感器,传感器安置在尽或许挨近每个触摸界面的方位,经过对每个触摸界面邻近的温度剖析,找出最高环节温增值。丈量的仪器选用Fluke数据收集体系(2680A),传感器选用T型热电偶,精度为±0.5℃。
主、从模块上CPU芯片暖流密度最高、有内置温度传感器,结温相差1℃以内,但从模块安装传感器更便利,所以挑选从模块CPU芯片内置传感器温度为起点,环境温度为结尾,对温升途径进行丈量,传感器布局如图5所示。模块加电2 h温度安稳,读取温增值,详细数据如表1所示。

注:丈量数据仅选取2种柔性导热资料丈量数据;温差为相邻两丈量点温度差
3.1 要害散热要素优化
表1数据得出模块热规划环节影响器材温升的最首要要素是插槽热阻。处理模块选用楔形锁紧结构,又因锁紧组织无法改进,故首要从改动插槽界面触摸热阻方面进行。
丈量惯例导电氧化外表插槽及垫铟箔、石墨、铝箔插槽及插槽涂改硅脂5种办法。一般导电氧化外表,模块插槽处温升为14~16 ℃。铟箔可将插槽温升下降至11~12℃,但铟箔较软且有必定的毒性,在插拔进程简单发生磨损,需规划专门的组织保证拔插时无法触摸,所以经济性差。石墨耐磨性差且简单碎裂,难以应用于工程。而铝箔自带背胶运用便利,可将插槽温升下降至9~10 ℃,但楔形锁紧组织力量大,当模块精度操控欠好时会形成触摸不良或将背胶挤出。硅脂作用最佳,插槽处温升下降至8~9℃,但硅脂易形成污染,保护不方便。文中经过剖析以为现有工艺条件可经过进步触摸面外表光洁度、加工精度及插槽安装面添加铝箔的办法来下降插槽热阻。
3.2 柔性导热资料挑选
芯片封装外形有封装公役,机械零件存在加工差错,当各类组件安装时,累计差错有或许挨近0.5 mm。为消除累计差错,一般在芯片与散热板之间安装柔性导热资料,经过导热资料的紧缩来衔接散热通路。
进步柔性导热资料的触摸压力可下降触摸热阻,但芯片外表所能接受的压力有严厉约束,挑选何种导热资料压力并不是仅有要素,还需考虑多方面要素,如芯片的暖流密度,导热资料的导热系数、弹性模量、本钱和可修理性等。
处理模块面临严苛的振荡、冲击环境,为下降芯片所接受环境压力的影响,应挑选愈加柔软的导热资料。从可修理性的视点考虑,应选用低触摸应力的导热资料。一般导热资料有单面带背胶和双面背胶两种,本文引荐挑选单面背胶资料。
经过测验导热系数为3、3.1、5、14、15、17 W/m·K的6种导热垫资料。从表1中截取测验数据标明,现在暖流密度条件下,器材结温并不跟着导热垫两边温差减小直线下降,单纯进步导热垫导热系数无法有用下降芯片温度,仿真数据相同证明此现象。剖析以为整个模块结构的热阻网络杂乱,器材结温凹凸并不由某个结构的要素独自决议,仅进步导热垫导热系数,对下降模块传热途径上的总热阻奉献缺乏,故改进作用并不显着。
暖流密度3 W/cm2的芯片,导热系数在7 W/m·K以上的导热垫可满意运用要求,因为更高的导热资料意味着较高的经济本钱,从经济视点动身,不能仅进步导热垫系数,而应从体系的视点动身进行挑选。考虑芯片管脚受力,处理器模块终究挑选导热系数为15W/m·K的导热资料。
4 结束语
经过热仿真、测验迭代优化的处理模块达到了运用要求,且留有余度,为相似高密度拼装模块的热规划供给了参阅。(1)热仿真应尽早参加结构规划,模块预布局后即展开热仿真。仿真与测验相结合,进行仿真比照计划、寻觅改进方向、优化计划,测验消除仿真差错,找到规划临界值,保证产品满意运用要求。并经过仿真、测验迭代堆集数据,更好的辅导规划。(2)影响器材温升要素很多,仅进步导热资料导热系数的办法并不经济,且下降单个环节热阻也不能显着下降芯片结温,只要对整个散热通路热阻操控获得均衡,才可有显着的改进作用。(3)进步导轨触摸面光洁度、合作精度,添加触摸压力及界面热传递资料是增强模块传热才能较为经济的挑选。









