5 嵌入用元件
焊盘衔接方法时,嵌入能够选用再流焊或许粘结剂等表面装置技术的大多数元件。为了防止板厚的极点增大而要运用元件厚度小的元件。裸芯片或许WLP情况下,它们的大多数研磨了硅(Si)的反面,包含凹块等在内的装置往后的高度为(300~150)mm以下。无源元件中选用0603型,0402型或许1005的低背型。导通孔衔接方法时,上面介绍的镀层衔接和导电胶衔接的各种案例都是选用Cu电极的元件。用作嵌入元件时铜(Cu)电极的无源元件厚度150 mm成为方针之一,还有更薄元件的开发例。
6EPASD 点评解析T V (TestVehicle)
6.1 测验运载工具(TV)概要
以说明元件嵌入PCB的技术课题为意图,制作了点评解析WG中的TV(Test Vehicle)并进行了点评。从2007年再次关于结构和规划的谈论,终究制作了如图9所示的裸芯片嵌入基板的结构。线路层为4层,L2~L3之间嵌入元件。依据元件嵌入PCB的用处,初期应该相同于HDI基板的谈论,而提出元件嵌入特有的课题被视为最实质的问题,嵌入部分以外极为简单的优先制作,层间衔接为贯穿孔。别离运用无卤FR-4和FR-5基材进行制作。
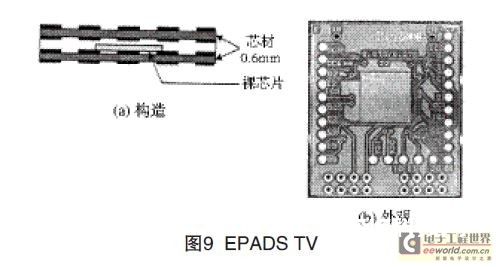
嵌入的元件是由SIPOS(System IntegrationPlatform Organization Standard)供应的“SIPOSTEG”,构成与PCB衔接的菊链式图形那样的焊盘装备。图10标明了这种图形和首要规范。其间电极上构成金(Au)螺拴形凸块(Stud Bump),选用面朝下(Facedown)的倒芯片衔接的装置方法。这时选用热压接合法和超声波法2种方法。因而制作成两种资料和两种装置方法的合计4种样品。
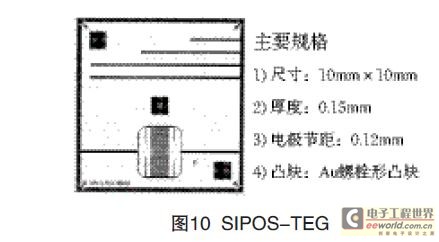
6.2 点评成果
2008年施行了TV制作,2009年度进行了点评解析。首要为了点评再流焊耐热性,选用JEDEC3级的条件施行前处理。许多样品再流焊往后产生起泡。
别的还伴跟着产生断线或许电阻上升。
图11标明了截面解析的一例。嵌入的芯片下方的底胶树脂与芯片之间产生剥离,部分剥离产生在螺栓形凸块与PCB电极界面。这种剥离是起泡的产生原因。耐热性的FR-5也产生若干起泡。因为四种条件中没有明显不同。所以以为产生起泡的首要原因在于结构自身。依据截面解析的成果芯片自身明显翘曲,因为嵌入往后内涵的残留应力在再流焊时被开释而产生变形,或许因为芯片自身的尺度或许PCB图形的影响等。关于翘曲方面,在内层板上装置时因为芯片与内层板的热膨胀系数不同而表现出凸状翘曲,可是如图11所示的起泡往后的截面中反而逆转为凹状翘曲而值得注意。
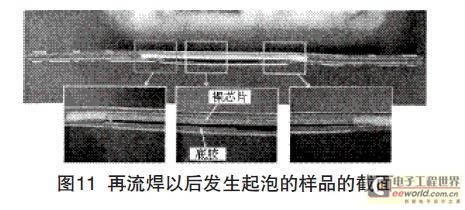
产生起泡的点评实质上是因为爆玉米花(Popcorn)现象引起的,运用不同的两种底胶树脂的装置方法都发现相同的起泡,因而以为PCB结构有很大影响。为了查询这种现象,第2次制作了TV-1′芯材厚度为0.1 mm和0.3 mm,导体图形有TV-1选用的铜(Cu)中心(Beta)图形和PCB的网且(Mesh)图形两种。合计四种样品。图12标明了TV-1′PCB的导体图形和层结构。各种结构施行了5次再流焊耐热实验,与TV-1′相同结构的芯材0.1mm/Cu中心图形再现起泡现象,而其它结构都没有产生起泡或许电阻上升,承认了结构改变的作用。
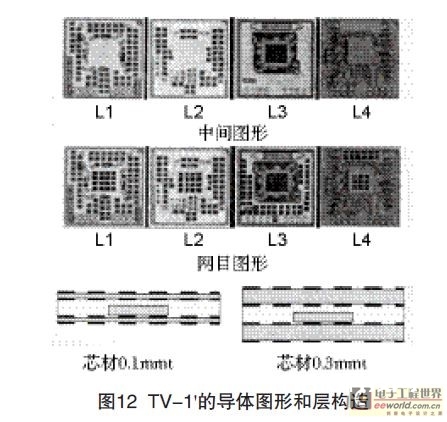
6.3 热变形解析
为了调查基材的厚度或许线路导体图形给予元件嵌入PCB的热变形行为的影响,运用模仿迄今取得的实验成果进行解析。依据前节叙说的EPADS TV的Geber数据制成三D模型(Model),经过解析从室温加热到260 ℃时的热变形行为而求得。解析时运用ADINA8.6(美国ADINA公司制作)进行非线性的弹性解析。解析以TV-1′为规范。基材厚度为0.1 mm和0.3 mm两种,PCB的导体设定为铜(Cu)中心图形和网目图形两种,施行合计组合成四种的解析。制成的模型如下。
(a)模型1 芯材0.1 mm厚/网目图形。
(b)模型2 芯材0.1 mm厚/中心图形。
(c)模型3 芯材0.3 mm厚/网目图形。
(d)模型4 芯材0.3 mm厚/中心图形。
别的嵌入的芯片为0.1 mm,厚度10 mm□,与TV相同的周边装备金(Au)凸块和下面填充底胶树脂的结构。实践的制作情况有所不同,在解析中室温下的应力和变形设定为0,求出加热到260 ℃时的热变行为。图13标明了热变形解析成果的一例。途中的PCB L1标明上面的,裸芯片嵌入部分的中心部表现出凸形状变形的倾向。它的周围收到裸芯部嵌入部变形的影响。变形行为跟着部位而有所不同,这是因为导体图形的形状和疏密的影响所造成的。解析的四种模型中。模型2适当于TV-1产生起泡的结构。
解析所取得的热变形量以模型2为最大,表现出与实践基板相同的倾向。模型2的变形量为108 mm,其它模型的变形量规模为46 mm ~ 60 mm.

6.4 与热变形实测的比较
为了验证热变形解析的准确性,进行了热变形行为的实测。样品制作成TV-1′,结构适当热变形解析的模型1~模型4供应实验。依据莫瑞光影法(Shadow Moire)的非触摸翘曲丈量一边加热到最高260 ℃一边进行丈量。图14标明了室温初始状况下翘曲分布图。与解析成果相反,因为L4侧具有凸状翘曲,所以在上面装备PCB L4.因为这种翘曲方向对应于图11中标明的起泡往后芯片翘曲方向,所以芯片在嵌入时和装置时表现出不同的翘曲。

从室温初始状况到260 ℃一边升温一边进行数点的丈量,承认了室温初始状况时翘曲小的倾向,即L1侧表现出翘曲行为,这一点与模仿的倾向共同。以室温初始状况的翘曲量为基准求出L1测变位量,表1标明了它与模仿成果的比较成果。厚度0.1 mm的结构中实测成果大大超出模仿成果的变形量。特别是模型2中呈现出很大剥离,尽管外观没有承认,可是也有可能产生微细的层间剥离。但是厚度0.3 mm的结构中,实测成果与模仿成果比较共同,标明元件嵌入PCB的热变形猜测是有用的。0.1 mm厚度的结构中两者的剥离点往后还有研讨的地步,能够选用弹性解析猜测热变形行为,在工业上比较有用,期待着有助于元件嵌。