原子层刻蚀和堆积工艺运用自限性反响,供给原子级操控。 泛林集团先进技能发展事业部公司副总裁潘阳博士 共享了他对这个论题的观点。
技能节点的每次前进都要求对制作工艺改变进行更严厉的操控。最先进的工艺现在能够到达仅7 nm的fin宽度,比30个硅原子稍大一点。半导体制作现已跨过了从纳米级到原子级工艺的门槛。工程师现在有必要重视结构的尺度改变,仅相当于几个原子巨细。由于多重图画形式等杂乱集成增加了工艺数量,进一步约束了每个进程答应的改变。3D NAND和finFET结构的杂乱性会带来更高应战。
关于半导体职业而言,操控工艺改变一直都是一大要害应战,由于它会直接影响到产品的功能、良率和可靠性,然后发生严重经济结果。工艺诱生的改变有多个来历,包含晶粒、晶圆和东西。要操控这些改变,一种办法是经过运用原子层堆积 (ALD) 和原子层刻蚀 (ALE) 等技能,这些技能自身比传统等离子体办法愈加准确。
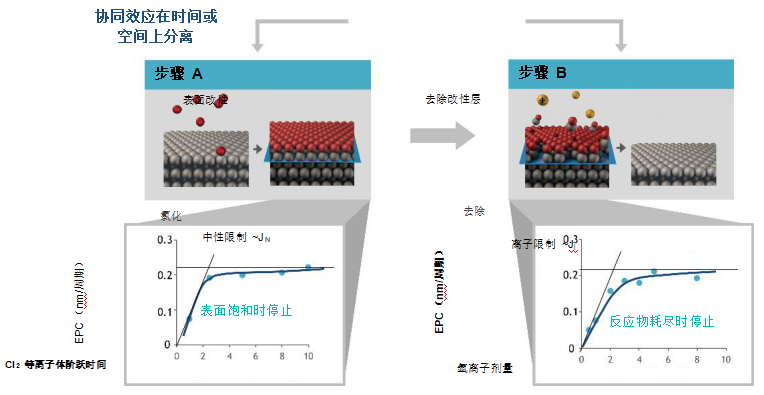
图 1. 原子层工艺中的一切半周期反响是自限性反响。
原子层工艺
原子层工艺包含堆积和刻蚀处理方案,它们具有一些一起的特征。与接连工艺不同,它们分周期进行,每个周期都会增加或去除有限固定数量的分子层。每个周期又分为若干半周期,每个半周期分别是不同的自限性工艺,为下个半周期预备外表。例如,在 SiO2 堆积中(图1和2),第一个半周期会吸附氧原子,这个进程是自限性的,遭到结合位点的约束。然后,剩余的氧被从腔室中铲除,外表露出在硅原子源下,硅原子与吸附的氧发生反响,构成一层 SiO2。这个半周期工艺也是自限性的,在这种情况下,它遭到氧的约束。原子层堆积的自限和有序的特性在先进逻辑和存储器芯片HVM中得到了广泛应用。
与堆积技能相同,原子层刻蚀相同分为若干半周期进行,这些半周期也是自限性的。例如,在硅刻蚀工艺中,第一个半周期将硅外表露出在氯下,氯与第一层硅原子结合,弱化它们与底层原子的键合(图2)。当外表饱满时,该进程中止,然后铲除未运用的氯。第二个半周期运用氩离子来碰击改性外表,去掉氯激活的硅顶层,而不是底层硅。氯化层去掉之后,周期完结,薄资料层已准确去除。
曩昔,要将原子层刻蚀工艺集成到大规模半导体生产中,咱们会受制于相对接连刻蚀工艺来说较低的刻蚀速率。以下两个要素结合在一起,削减了较低刻蚀速率对全体产值的影响。第一个要素是特征尺度继续减小,然后削减了要去除的资料数量,以及所需的ALE周期数。第二个要素是ALE技能的前进,例如快速气体交流技能,它们明显提高了循环速度。跟着咱们越来越多地需求对较小结构完成原子级操控,这种技能引起了更多重视。原子层刻蚀还供给了其他一些重要优势,包含改善的方向性(异向性)、更润滑的外表、更好的资料选择性、更均匀的刻蚀外表、较少的外表损坏和混合,消除了图画密度引起的非均匀效应,并改善了晶圆间的均匀性。
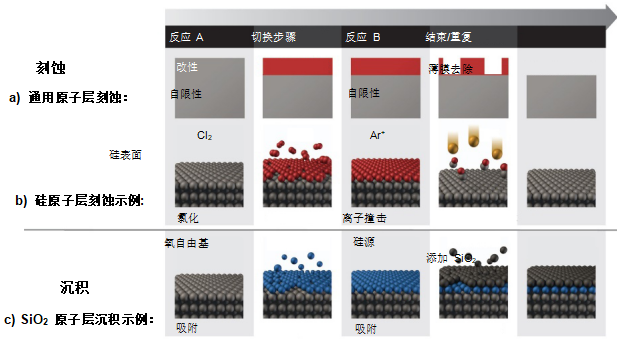
图 2. 原子层工艺能够去除或堆积资料。在以上刻蚀示例中,氯吸附到硅外表,然后经过氩离子碰击去除改性层。在堆积示例中,氧吸附到硅外表,硅与改性外表层相结合,堆积二氧化硅。
立异的原子层刻蚀与原子层堆积技能处理方案

图 3. 边际放置差错 (EPE) 终究约束空间扩展。50%的BEOL区域是为EPE保存的。因EUV光刻技能中随机缺点引起的线和圆形边际粗糙度极大地促进了EPE的发生。
EUV 光刻技能中的随机缺点
在7nm和10nm节点选用EUV光刻技能的制作商面临着随机缺点的应战。EUV光的较短波长使其能够聚集至更精密图画,但也意味着每个光子具有更多能量,发生更多光致酸,一起曝光更很多的光刻胶。EUV体系十分贵重,并且有必要完成较高的产值才能在本钱基础上与传统 (i193) 光刻技能进行竞赛,因而它们选用短曝光、低光子剂量以及以最小量光子就能够完成曝光的化学扩大光刻胶 (CAR)。光刻胶中光子与光致酸在空间与时刻散布上的随机改变性会导致随机缺点,这本质上是一种计算块度,在已创立的光刻胶图画中体现为边际和外表粗糙度。圆形边际粗糙度 (CER) 以及线边际粗糙度 (LER) 均是边际定位差错 (EPE) 的组成部分,终究约束了特征尺度或许削减的程度。在先进节点中,50% 以上的BEOL区域是为EPE保存的;设备扩展遭到EPE扩展的约束并且需求节点对节点EPE下降30%(图 3)。
原子层刻蚀有助于削减这些随机缺点的影响。由于它在自限性进程中逐层进行,并且由于工艺进程将化学活性物质与高能离子相别离,因而原子层刻蚀不会发生传统的刻蚀工艺中呈现的粗糙的镶边层。更重要的是,原子层刻蚀与原子层堆积的重复循环,能够下降EUV中随机缺点引起的粗糙度。凹凸外表比平面具有较高的外表体积比,这就导致在原子层刻蚀的进程中凸面被整平,而在原子层堆积的进程中凹面被填充。不只随机缺点十分小,并且在这一平坦工艺进程中去除和堆积的层也十分薄,大约为半纳米。现实标明,这一工艺下降了CER并提高了小尺度孔的CD均匀度。相同,它也下降了LER、改善了CDU,铲除了细微的(小于10nm)线宽和间隔中扎手的短路缺点(图 4)。
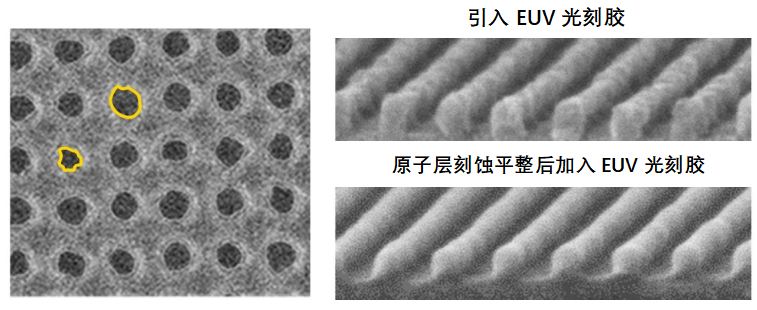
图 4. 左图 – 黄色轮廓线表明EUV光刻技能中随机改变引起的光刻胶中孔的部分不均匀。右图 – 原子层刻蚀与原子层堆积重复循环能够明显下降光刻胶线的粗糙度。(Imec测验结构)
自对准触摸孔刻蚀
自对准触摸孔 (SAC) 经过将源极和漏极接点定位到间隔栅极更近的方位而完成继续的缩放。在这一工艺中,栅极经过横向氮化硅间隔层和上覆的掩盖层与源极和漏极接点完成阻隔。SAC刻蚀是最具应战性的刻蚀工艺之一,它能够在触摸点堆积之前去除相邻的二氧化硅。它有必要具有高度选择性,然后铲除氧化物并使氮化硅垫片坚持完好。在接连刻蚀工艺中,选择性是经过堆积一个薄的氟碳聚合物涂层来完成的。在刻蚀进程中,氧化物中的可用氧分会烧掉聚合物中的碳,然后使刻蚀继续进行。而当聚合物掩盖氮化物时,没有氧分可用,而刻蚀则被按捺。问题存在于氮化硅垫片的顶处。在露出视点为45˚-70˚时,溅射速率最大;因而,在角落处的刻蚀速度比在平面上快,并且跟着角落变得愈加油滑,防护聚合物就更难粘附。角落处的过度油滑和腐蚀终究将导致栅极与源极/漏极之间的短路。
原子层刻蚀 (ALE) 经过将防护层的堆积与刻蚀进程进行阻隔,然后处理这一问题(图 5)。堆积进程中不存在离子,因而在堆积进程中存在最小溅射,且聚合物能够均匀地堆积在包含角落的方位上。在刻蚀循环进程中,只要离子 (Ar+)存在,氧化物中的氧烧掉聚合物,而氟碳聚合物中的氟腐蚀氧化物。当聚合物消失时,氟也随之消失,假如偏压功率低于氮化硅的溅射阈值,则刻蚀中止。在氮化物上,没有氧气存在,使聚合物根本坚持完好,氟的含量极低,使刻蚀得到按捺。ALE下降了角落的油滑度,使聚合物厚度变薄,因而能够运用更薄的垫片。ALE运用自限性半循环将外表改性进程与自动刻蚀进程相别离,与接连刻蚀工艺比较供给了更大的灵活性和更好的操控。(值得一提的是,经过调理各种工艺参数,能够对选择性进行反转,优先刻蚀氮化物而非氧化物。)
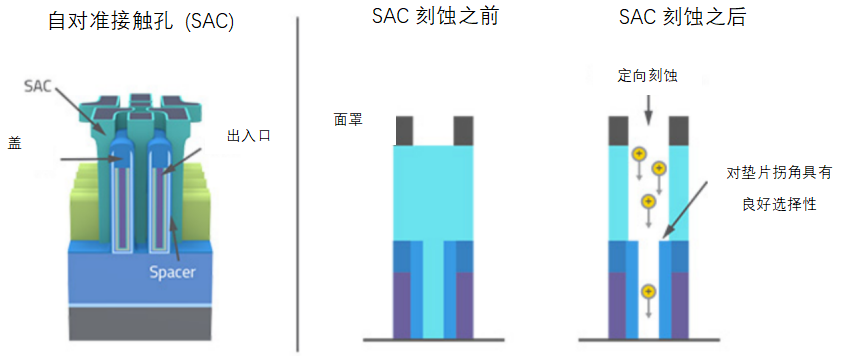
图 5. 自对准触摸孔选用一个横向垫片将栅极与源漏触摸孔相阻隔。ALE避免在垫片上角过度刻蚀,这在接连刻蚀工艺中很常见。
3D NAND字线的钨堆积
3D NAND运用笔直整合极大地增加了存储设备的存储密度。以往,结构局限于两个维度,经过减小尺度然后约束密度;现在,结构在第三个维度中得以扩展。这些设备包含十分规几何图形以及极高的深宽比特征,这带来了独有的工艺应战。
其间最具应战性的是向字线中填充导电钨。3D NAND替换堆叠氧化物和氮化物介电层,当时一代中有多达96层,更高层数还在研制中(图 6)。密布摆放且具有深邃宽比的孔浸透至这些层中,依照深邃宽比通道将摆放分为字线。为了创立存储单元,有必要移除氮化物层并以钨进行替换。这种钨有必要经过深(笔直深度 50:1)通道引进,然后横向分散,然后以无空泛的超共形堆积办法填充(之前的)氮化物水平面(横向比约 10:1)。原子层堆积能够一次堆积一个薄层,这就保证了均匀填充,并避免因阻塞而发生的空地。
一种成功的办法就是在填充工艺中增加形状选择性按捺剂,避免在填充较深邃宽比结构之前,呈现较低深宽比结构中的过度堆积。由内而外的ALD工艺能够彻底填充横向(水平)线且不留空地,一起最大极限地削减了笔直通道中的堆积,然后提高了电气功能和工艺成品率。

图 6. 3D NAND选用杂乱的深邃宽比结构。创立字线需求超共形钨堆积,而这有必要填充笔直和水平空间且不留空地。
结语
原子层刻蚀与堆积工艺运用自限性反响,供给原子级的操控。工艺产值提高、从更小的结构中移除的资料削减、以及对原子级操控的需求不断增加,这些要素都从头引起了人们对原子层刻蚀的爱好。原子层工艺供给的操控水平,保证其在当时甚至未来的半导体制作业中将发挥越来越重要的效果。