MOSFET和IGBT内部结构不同,决议了其运用范畴的不同。
1、因为MOSFET的结构,一般它可以做到电流很大,可以到上KA,可是条件耐压才能没有IGBT强。
2、IGBT可以做很大功率,电流和电压都可以,便是一点频率不是太高,现在IGBT硬开关速度可以到100KHZ,那已经是不错了。不过相关于MOSFET的作业频率仍是沧海一粟,MOSFET可以作业到几百KHZ,上MHZ,以致几十MHZ,射频范畴的产品。
3、就其运用,依据其特色:MOSFET运用于开关电源,镇流器,高频感应加热,高频逆变焊机,通讯电源等等高频电源范畴;IGBT会集运用于焊机,逆变器,变频器,电镀电解电源,超音频感应加热等范畴。
开关电源 (Switch Mode Power Supply;SMPS) 的功能在很大程度上依赖于功率半导体器材的挑选,即开关管和整流器。
尽管没有万全的计划来处理挑选IGBT仍是MOSFET的问题,但针对特定SMPS运用中的IGBT 和 MOSFET进行功能比较,确认要害参数的规模仍是能起到必定的参阅效果。
本文将对一些参数进行评论,如硬开关和软开关ZVS (零电压转化) 拓扑中的开关损耗,并对电路和器材特性相关的三个首要功率开关损耗—导通损耗、传导损耗和关断损耗进行描绘。此外,还经过举例说明二极管的康复特性是决议MOSFET 或 IGBT导通开关损耗的首要要素,评论二极管康复功能关于硬开关拓扑的影响。
导通损耗
除了IGBT的电压下降时刻较长外,IGBT和功率MOSFET的导通特性非常相似。由根本的IGBT等效电路(见图1)可看出,彻底调理PNP BJT集电极基极区的少量载流子所需的时刻导致了导通电压拖尾(voltage tail)呈现。

这种推迟引起了类饱满 (Quasi-saturation) 效应,使集电极/发射极电压不能当即下降到其VCE(sat)值。这种效应也导致了在ZVS情况下,在负载电流从组合封装的反向并联二极管转化到 IGBT的集电极的瞬间,VCE电压会上升。IGBT产品标准书中列出的Eon能耗是每一转化周期Icollector与VCE乘积的时刻积分,单位为焦耳,包括了与类饱满相关的其他损耗。其又分为两个Eon能量参数,Eon1和Eon2。Eon1是没有包括与硬开关二极管康复损耗相关能耗的功率损耗;Eon2则包括了与二极管康复相关的硬开关导通能耗,可经过康复与IGBT组合封装的二极管相同的二极管来丈量,典型的Eon2测验电路如图2所示。IGBT经过两个脉冲进行开关转化来丈量Eon。第一个脉冲将增大电感电流以达致所需的测验电流,然后第二个脉冲会丈量测验电流在二极管上康复的Eon损耗。
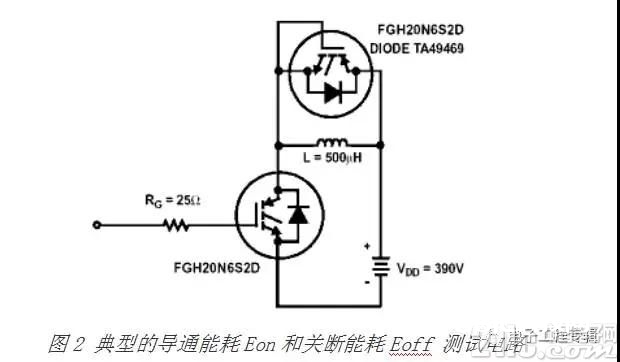
在硬开关导通的情况下,栅极驱动电压和阻抗以及整流二极管的康复特性决议了Eon开关损耗。关于像传统CCM升压PFC电路来说,升压二极管康复特性在Eon (导通) 能耗的操控中极为重要。除了挑选具有最小Trr和QRR的升压二极管之外,保证该二极管具有软康复特性也非常重要。软化度 (Softness),即tb/ta比率,对开关器材发生的电气噪声和电压尖脉冲 (voltage spike) 有适当的影响。某些高速二极管在时刻tb内,从IRM(REC)开端的电流下降速率(di/dt)很高,故会在电路寄生电感中发生高电压尖脉冲。这些电压尖脉冲会引起电磁搅扰(EMI),并或许在二极管上导致过高的反向电压。
在硬开关电路中,如全桥和半桥拓扑中,与IGBT组合封装的是快康复管或MOSFET体二极管,当对应的开关管导通时二极管有电流经过,因而二极管的康复特性决议了Eon损耗。所以,挑选具有快速体二极管康复特性的MOSFET非常重要。不幸的是,MOSFET的寄生二极管或体二极管的康复特性比业界现在运用的分立二极管要缓慢。因而,关于硬开关MOSFET运用而言,体二极管常常是决议SMPS作业频率的束缚要素。
一般来说,IGBT组合封装二极管的挑选要与其运用匹配,具有较低正向传导损耗的较慢型超快二极管与较慢的低VCE(sat)电机驱动IGBT组合封装在一起。相反地,软康复超快二极管,可与高频SMPS2开关形式IGBT组合封装在一起。
除了挑选正确的二极管外,规划人员还可以经过调理栅极驱动导通源阻抗来操控Eon损耗。下降驱动源阻抗将进步IGBT或MOSFET的导通di/dt及减小Eon损耗。Eon损耗和EMI需求折中,因为较高的di/dt 会导致电压尖脉冲、辐射和传导EMI添加。为挑选正确的栅极驱动阻抗以满意导通di/dt 的需求,或许需求进行电路内部测验与验证,然后依据MOSFET转化曲线可以确认大约的值 (见图3)。
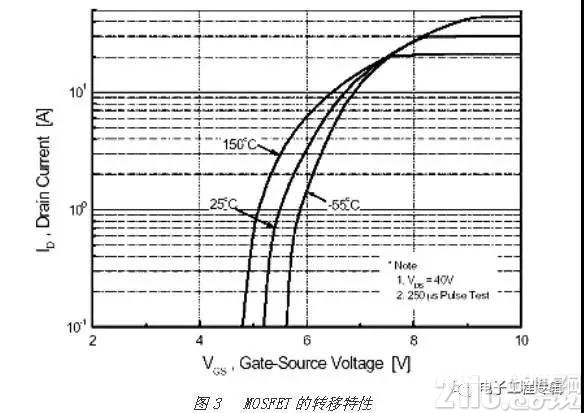
假定在导通时,FET电流上升到10A,依据图3中25℃的那条曲线,为了到达10A的值,栅极电压有必要从5。2V转化到6。7V,均匀GFS为10A/(6。7V-5。2V)=6。7mΩ。

公式1 取得所需导通di/dt的栅极驱动阻抗
把均匀GFS值运用到公式1中,得到栅极驱动电压Vdrive=10V,所需的 di/dt=600A/μs,FCP11N60典型值VGS(avg)=6V,Ciss=1200pF;所以可以核算出导通栅极驱动阻抗为37Ω。因为在图3的曲线中瞬态GFS值是一条斜线,会在Eon期间呈现改变,意味着di/dt也会改变。呈指数衰减的栅极驱动电流Vdrive和下降的Ciss作为VGS的函数也进入了该公式,体现具有令人惊奇的线性电流上升的整体效应。
相同的,IGBT也可以进行相似的栅极驱动导通阻抗核算,VGE(avg) 和 GFS可以经过IGBT的转化特性曲线来确认,并运用VGE(avg)下的CIES值替代Ciss。核算所得的IGBT导通栅极驱动阻抗为100Ω,该值比前面的37Ω高,标明IGBT GFS较高,而CIES较低。这儿的要害之处在于,为了从MOSFET转化到IGBT,有必要对栅极驱动电路进行调理。
传导损耗需谨慎
在比较额定值为600V的器材时,IGBT的传导损耗一般比相同芯片巨细的600 V MOSFET少。这种比较应该是在集电极和漏极电流密度可显着感测,并在指明最差情况下的作业结温下进行的。例如,FGP20N6S2 SMPS2 IGBT 和 FCP11N60 SuperFET均具有1℃/W的RθJC值。图4显现了在125℃的结温下传导损耗与直流电流的联系,图中曲线标明在直流电流大于2。92A后,MOSFET的传导损耗更大。
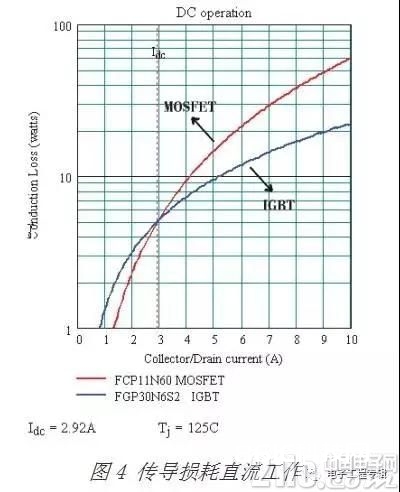
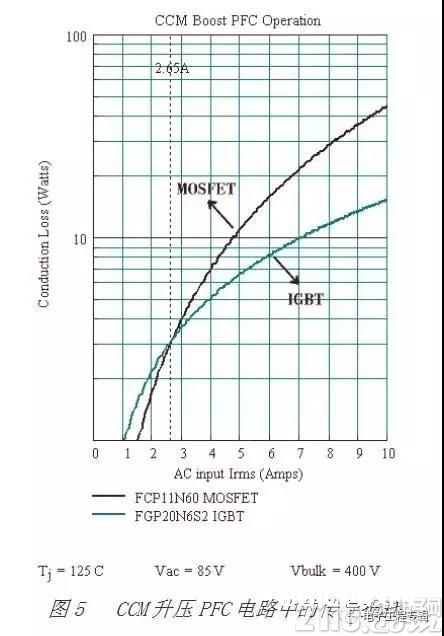
不过,图4中的直流传导损耗比较不适用于大部分运用。一起,图5中显现了传导损耗在CCM (接连电流形式)、升压PFC电路,125℃的结温以及85V的沟通输入电压Vac和400 Vdc直流输出电压的作业形式下的比较曲线。图中,MOSFET-IGBT的曲线相交点为2。65A RMS。对PFC电路而言,当沟通输入电流大于2。65A RMS时,MOSFET具有较大的传导损耗。2。65A PFC沟通输入电流等于MOSFET中由公式2核算所得的2。29A RMS。MOSFET传导损耗、I2R,使用公式2界说的电流和MOSFET 125℃的RDS(on)可以核算得出。把RDS(on)随漏极电流改变的要素考虑在内,该传导损耗还可以进一步准确化,这种联系如图6所示。
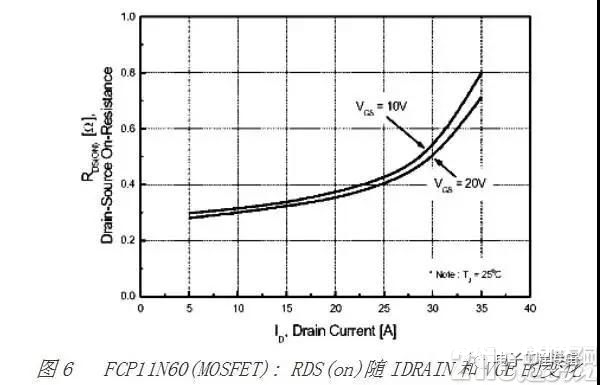
一篇名为“怎么将功率MOSFET的RDS(on)对漏极电流瞬态值的依赖性包括到高频三相PWM逆变器的传导损耗核算中”的IEEE文章描绘了怎么确认漏极电流对传导损耗的影响。作为ID之函数,RDS(on)改变对大大都SMPS拓扑的影响很小。例如,在PFC电路中,当FCP11N60 MOSFET的峰值电流ID为11A——两倍于5。5A (标准书中RDS(on) 的测验条件) 时,RDS(on)的有用值和传导损耗会添加5%。
在MOSFET传导极小占空比的高脉冲电流拓扑结构中,应该考虑图6所示的特性。假如FCP11N60 MOSFET作业在一个电路中,其漏极电流为占空比7。5%的20A脉冲 (即5。5A RMS),则有用的RDS(on)将比5。5A(标准书中的测验电流)时的0。32欧姆大25%。

公式2 CCM PFC电路中的RMS电流
式2中,Iacrms是PFC电路RMS输入电流;Vac是 PFC 电路RMS输入电压;Vout是直流输出电压。
在实践运用中,核算IGBT在相似PFC电路中的传导损耗将愈加杂乱,因为每个开关周期都在不同的IC上进行。IGBT的VCE(sat)不能由一个阻抗表明,比较简略直接的办法是将其表明为阻抗RFCE串联一个固定VFCE电压,VCE(ICE)=ICE×RFCE+VFCE。所以,传导损耗便可以核算为均匀集电极电流与VFCE的乘积,加上RMS集电极电流的平方,再乘以阻抗RFCE。
图5中的示例仅考虑了CCM PFC电路的传导损耗,即假定规划方针在保持最差情况下的传导损耗小于15W。以FCP11N60 MOSFET为例,该电路被束缚在5。8A,而FGP20N6S2 IGBT可以在9。8A的沟通输入电流下作业。它可以传导超越MOSFET 70% 的功率。
尽管IGBT的传导损耗较小,但大大都600V IGBT都是PT (Punch Through,穿透) 型器材。PT器材具有NTC (负温度系数)特性,不能并联分流。或许,这些器材可以经过匹配器材VCE(sat)、VGE(TH) (栅射阈值电压) 及机械封装以有限的成效进行并联,以使得IGBT芯片们的温度可以保持一致的改变。相反地,MOSFET具有PTC (正温度系数),可以供给杰出的电流分流。
关断损耗——问题没有完毕
在硬开关、钳位理性电路中,MOSFET的关断损耗比IGBT低得多,原因在于IGBT 的拖尾电流,这与铲除图1中PNP BJT的少量载流子有关。图7显现了集电极电流ICE和结温Tj的函数Eoff,其曲线在大大都IGBT数据表中都有供给。 这些曲线根据钳位理性电路且测验电压相同,并包括拖尾电流能量损耗。
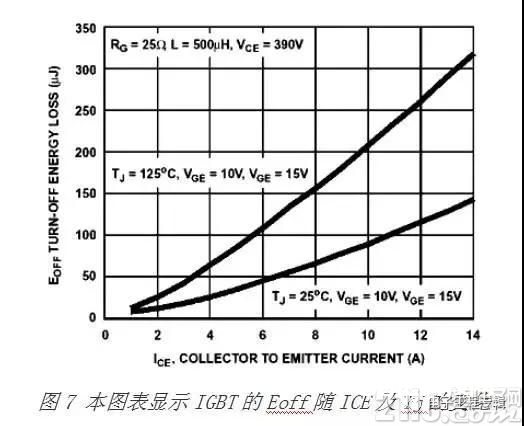
图2显现了用于丈量IGBT Eoff的典型测验电路, 它的测验电压,即图2中的VDD,因不同制造商及单个器材的BVCES而异。在比较器材时应考虑这测验条件中的VDD,因为在较低的VDD钳位电压下进行测验和作业将导致Eoff能耗下降。
下降栅极驱动关断阻抗对减小IGBT Eoff损耗影响极微。如图1所示,当等效的大都载流子MOSFET关断时,在IGBT少量载流子BJT中仍存在存储时刻推迟td(off)I。不过,下降Eoff驱动阻抗将会削减米勒电容 (Miller capacitance) CRES和关断VCE的 dv/dt形成的电流注到栅极驱动回路中的危险,防止使器材从头偏置为传导状况,然后导致多个发生Eoff的开关动作。
ZVS和ZCS拓扑在下降MOSFET 和 IGBT的关断损耗方面很有优势。不过ZVS的作业优点在IGBT中没有那么大,因为当集电极电压上升到答应剩余存储电荷进行耗散的电势值时,会引发拖尾冲击电流Eoff。ZCS拓扑可以提高最大的IGBT Eoff功能。正确的栅极驱动次序可使IGBT栅极信号在第二个集电极电流过零点曾经不被铲除,然后明显下降IGBT ZCS Eoff 。
MOSFET的 Eoff能耗是其米勒电容Crss、栅极驱动速度、栅极驱动关断源阻抗及源极功率电路途径中寄生电感的函数。该电路寄生电感Lx (如图8所示) 发生一个电势,经过束缚电流速度下降而添加关断损耗。在关断时,电流下降速度di/dt由Lx和VGS(th)决议。假如Lx=5nH,VGS(th)=4V,则最大电流下降速度为VGS(th)/Lx=800A/μs。

总结:
在选用功率开关器材时,并没有万全的处理计划,电路拓扑、作业频率、环境温度和物理尺度,所有这些束缚都会在做出最佳挑选时起着效果。
在具有最小Eon损耗的ZVS 和 ZCS运用中,MOSFET因为具有较快的开关速度和较少的关断损耗,因而可以在较高频率下作业。
对硬开关运用而言,MOSFET寄生二极管的康复特性或许是个缺陷。相反,因为IGBT组合封装内的二极管与特定运用匹配,极佳的软康复二极管可与更高速的SMPS器材相配合。
后语:MOSFE和IGBT是没有本质区别的,人们常问的“是MOSFET好仍是IGBT好”这个问题自身便是过错的。至于咱们为何有时用MOSFET,有时又不必MOSFET而选用IGBT,不能简略的用好和坏来区别,来断定,需求用辩证的办法来考虑这个问题。