全球微型化趋势下,空前增加的电力电子开展以及随同之下更高效的出产功率,是这一高端职业寻求更高效灌封以及封装技能的首要动力。粘合剂工业对这一趋势作出了积极响应。市面上如漫山遍野般呈现了许多新研制的产品。
环氧树脂简直专用于需求耐高温、可反抗机械作用力,耐化学腐蚀的状况。它的作用原理是:环氧树脂虽不尽相同, 但为了例如到达最高牢靠性,它需求与专门的硬化剂合作运用,才干够保证粘合剂分子间构成特别严密的交联。这样才干使得灌封和封装关于温度和各种介质具有较高的反抗力,可以持久地在滚烫的传动装置润滑油和腐蚀介质中运用。
灌封与封装,最高适用温度达 250 °C
近些年来,许多工业范畴关于电子组件的温度要求进一步进步。关于轿车上的传感器或采油设备来说当然是毋庸置疑的。而关于电力电子设备来说更是如此,因为流经小型组件的电流强度越来越大,导致积累的热量也因而骤增,进一步提升了耐高温的要求。
曾经,封装最高适用温度可达180℃,而现在实践运用中却常超越这一温度。不过,新研制的产品现已将这一温度极限又进步了 70 °C ,适用温度规模到达 -65 °C 到 250 °C 。
虽然含有很多填料,这些耐高温封装及灌封资料,在进步耐受温度规模的一起,依然坚持高耐介质性、适用广泛的粘附力、高强度、安稳的加工功能以及杰出的活动性。

在最高达250 °C 的状况下维护元件免遭腐蚀性物质腐蚀: 调配特别硬化剂的高温封装工艺 (Figure: DELO)
即便在 250°C 的条件下贮存 500 小时后,它的拉伸强度仍可达 50 MPa。就算温度超越 200 °C,它仍具有很高的耐温性与粘合强度。在 250°C 下经过 500 小时存储后,其在 220 °C 的陶瓷上测得的紧缩剪切强度为 8 MPa,这适当于 800 N/cm² 。
光固化快速固定工艺,进步了粘合精度,并构成特定的封装成果
到现在为止,不管是在180 °C 仍是 250 °C的条件下,高端工业范畴的灌封及封装粘合剂都为纯热固化产品。因为增加其间的特别硬化剂必须在100 °C以上的条件下才会消融,随后才干与树脂发生反响。
虽然近期问世的双固化灌封资料也需求进行热固化工艺。不过,这类混合产品可以在初期经过光固化进行预固定——如此可进步粘合精度,构成特定的溢胶边,使得更易于处理已开始固定的元件。
更重要的是,在可以维护芯片的圆顶封装运用中,运用这一工艺会在外表先构成一张表皮,然后“冻住”住胶滴的形状,使其在后续热固化进程中不会活动。这意味着指定形状的圆顶封装可用于微型化规划所要求的空间窄小的电路板上。与可代替的筑坝填充计划比较,光固化工艺还可以节省一个加工进程。
在两个阶段的固化工序中,粘合剂先在UV光下照耀1到5秒,时刻长短取决于LED灯的光强。在常用的FR4电路板上,粘合剂经过光预固化的剪切强度可以超越1N。随后FR4电路板在150 °C的温度下经过热固化30分钟到达其终究剪切强度50MPa。
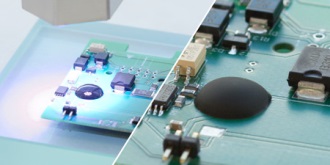
光固化快速固定技能的呈现,使那些要求高牢靠性的运用范畴具有了更多或许性 (图片来历: DELO)
可光固化的环氧树脂具有适用广泛的粘附力,而且因其优异的触变活动性,十分简单加工操作。因为混合的化学结构,温度极限略低于那些纯耐高温化合物。但前者在180 °C的条件下功能依然很优异。它的耐介质性也极强:在传动装置润滑油、汽油或甲醇等腐蚀介质里放置500小时今后,它的力学功能仅发生纤细改动。关于可损害大多数粘合剂功能的印刷油墨,该产品也显现出了高耐抗性。
堆叠的胶滴构筑出精细的结构
另一种叫做筑坝封装的办法,不仅能习惯日趋微型化的规划潮流,而且牢靠度很高。它们可先构成一堵又薄又高的墙,特别适用于轿车与工业运用范畴。
它们的特别之处在于比起前一代“筑坝”产品,填料更细腻,因而可以用针状点胶设备点出直径最小为 250 μm 的用于封装的胶滴。凭仗超高的粘度(最高可达160000 mPas),这种粘合剂的另一特性便是高抗活动性。粘合剂的高宽比可达2.5,这意味着胶滴的高度到达宽度的两倍也不会坍毁。
以上这些功能使得这种易于处理的粘合剂特别合适运用于纤细的结构,例如作为传感器之间极窄的分隔墙体。粘合剂的堆叠被称作"堆积坝"(dam stacking),(依据不同的粘合剂)这种工艺也有或许各胶层无需独自固化即可堆积起来,这简化了出产流程。

在芯片和传感器周围构建精细的结构: 专为电子元件研制的新”筑坝”粘合剂 (图片来历: DELO)
这些不崩塌的“筑坝”产品相同关于酸、油和其它腐蚀性物质具有优异的反抗力,而且具有很低的吸水性。它们的适用温度最高可达 200 °C 。在室温条件下,它在FR4电路板上的紧缩剪切强度到达 49 MPa . 即便是在200°C的环境下贮藏500小时今后,这一数值依然维持在 43 MPa,仅有纤细下降。
它的热膨胀系数(CTE)为24 ppm/K,接合180°C的玻璃化温度,可以使其在很大的温度规模内坚持极低的翘曲度。 因而,封装内部的应力得以最小化。
这类“筑坝”产品有两种不同的标准:一种是纯热固化粘合剂,另一种是抗活动性更高的双固化粘合剂。用户可以经过设定特定的时刻和温度,灵敏地操控固化进程。例如,在150°C时用20分钟完结固化,或许在125°C时用90分钟完结固化。因为这种粘合剂活动性极低,因而高宽比得以坚持不变。胶层高度在整个热固化进程中亦不会改动。
低翘曲率满意了大面积芯片灌封
不管关于牢靠性的要求有多高,制造商依然会把本钱效益放在反常重要的方位上。在芯片出产与芯片的再加工上,比方芯片封装范畴,各大制造商均倾向于挑选性价比更合理的工艺。在这一潮流下,制造商们越来越多地将很多相同的元件拼装在一块印刷电路板上,随后将这些元件彻底封装起来,最终再把它们切割成多个独自的已封装好的元件。另一种办法是对彻底拼装结束的印刷电路板进行封装,而不是用外壳来维护电路板免遭环境影响。
大面积灌封可以显著地缩短加工时刻,大大节省本钱。但在实践运用中,这一办法常常遭受瓶颈。在面临高化学应力和热应力时,大面积封装这一加工方法会在固化进程中形成印刷电路板的翘曲。这导致元件之间发生张力,令独自切割变得困难。形成翘曲的原因是印刷电路板和封装资料的热膨胀系数不相同,前者为10-20 ppm/K,后者一般高于 20 ppm/K。
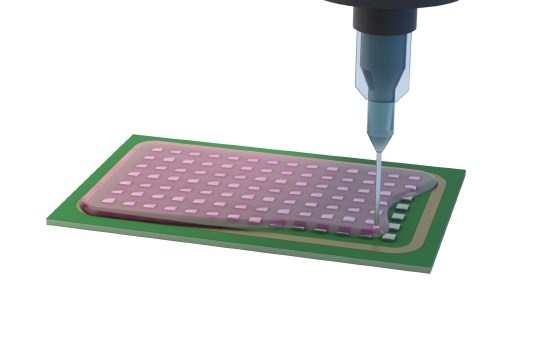
印刷电路板的大面积封装 (图片来历: DELO)
为了处理这个问题,并满意对牢靠度要求极高的运用范畴的需求,咱们研制出了优化的封装资料,其特点是热膨胀系数极低,仅为 11 ppm/K。这样就把翘曲度降到最低,令这种封装资料成为高功率大面积芯片封装的最佳挑选。
客户还可以挑选增加不同的荧光剂,以监控点胶工艺,在粘合剂固化之前检测一切元件是否已彻底掩盖。关于高价值元件来说,这一选项肯定值得考虑。
现在来说,这类产品的温度上限是 165 °C,而且具有超卓的防潮性和耐介质才能。此外,就算基材不加热,它们仍具有优异的活动性,也可以合作运用筑坝填充工艺到达作用。运用这种封装资料时,您还可以设置不同的固化参数:在温度为 150 °C 时,最多只需20分钟即可敏捷固化;关于单组分的产品,您可以挑选将固化温度降低到 100 °C;关于双组分的产品,您可以挑选将固化温度设为 125 °C 。这样一来,即便是对温度适当灵敏的元件也可以牢靠地固化。
定论
接受最高 250 °C 的温度、高机械负荷,而且持久地触摸具有腐蚀性的介质:在苛刻的环境条件下,高端封装资料与灌封用料是维护灵敏电子元件的关键因素。许多新研制的产品使得现在的制造商们可以满意逐渐升高的电力电子设备的技能要求,满意呼声渐涨的微型化需求,一起进步出产功率。