器材的良率在很大程度上依赖于恰当的工艺标准设定和对制作环节的差错操控,在单元尺度更小的先进节点上就更是如此。曩昔为了辨认和避免工艺失效,必需要经过很多晶圆的制作和测验来搜集数据,然后对搜集到的数据进行相关性剖析,整个进程费时且贵重。现在半导体虚拟制作东西(例如SEMulator3D®)的呈现改变了这一现状,让咱们能够在“虚拟”环境下完结以上试验。甚至在硅资料中进行工艺试验之前,虚拟制作就能够用于了解工艺之间的相互影响和工艺过程灵敏度以完成最大化良率。本文将经过一个简略示例来演示怎么经过虚拟制作来进步7nm节点特定结构的良率,其间使用到的技能包含失效分类、良率猜测和工艺窗口优化。
良率进步与失效分类
A. 失效分类界说
边际定位差错是导致后段制程良率丢失的首要失效形式[1]。下面用简略实例阐明,假定M1由金属A(MA)和金属B(MB)组成【一般由LELE(光刻-刻蚀-光刻-刻蚀),或自对准两层图形化技能(SADP)工艺产生】,而触摸孔(VC)被规划连接到MB。
金属要害尺度CD(或SADP工艺中的心轴CD)或VC CD或金属至VC的套准精度存在工艺差错,会引起因通孔和金属层之间产生边际定位差错而导致的良率丢失。
如下失效分类别离对应不同的CD和套准差错组合(见图1):
1、 高触摸电阻(HR):VC和MB触摸面积过小
2、 VC-MA漏电(VML):VC至MA的间隔过小
3、 MA-MB漏电(MML):MA至MB的间隔过小
4、 VC-MB开路(VMO):VC未触摸MB,两者之间没有堆叠
5、 VC-MA短路(VMS):VC触摸MA,两者之间有部分堆叠
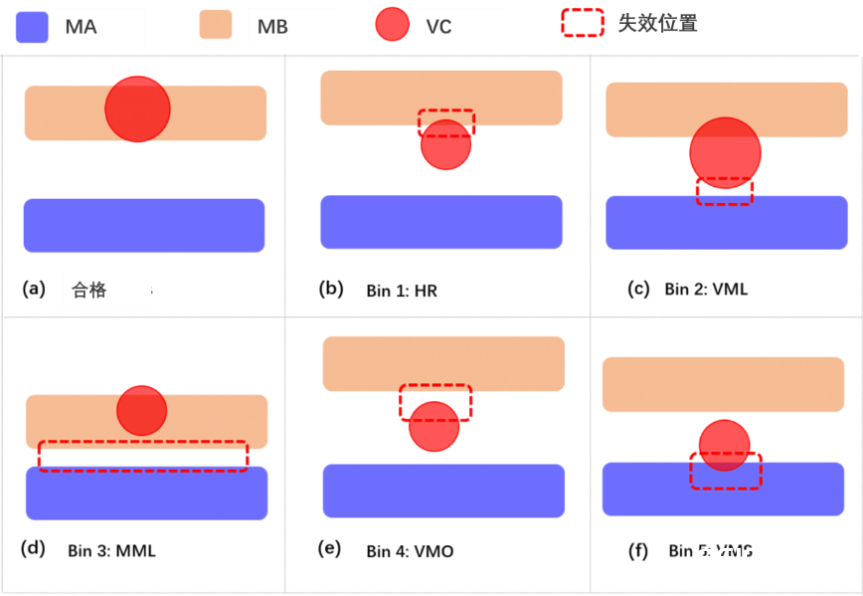
图1. 分类图示(a)合格,(b)HR,(c)VML,(d)MML,(e)VMO,(f)VMS
B. 结构构建与校准,以及失效形式生成与辨认
为了演示怎么经过虚拟制作进步良率,现构建一个7nm的 VC和M1工艺。在生成并校准虚拟工艺结构之后,履行一系列虚拟量测过程。图2展现了在虚拟结构上相应的丈量方位,依据丈量成果,能够将当时失效归入相应的失效分类。
依据特定的标准和规矩,能够依据丈量成果主动完成失效形式分类。
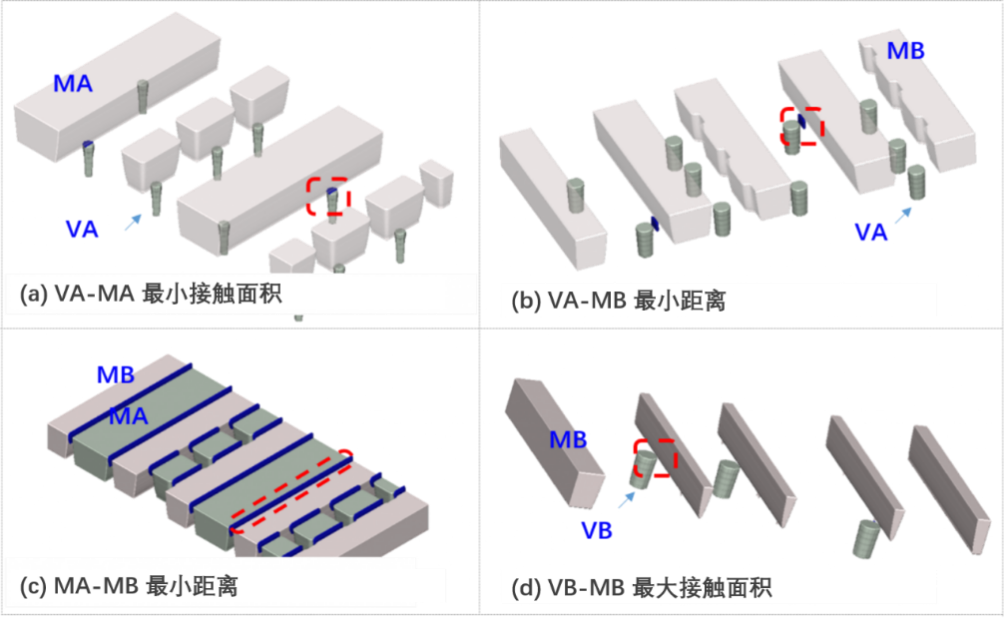
图2 虚拟丈量(结构检索)(a)VA-MA最小触摸面积,(b)VA-MB最小间隔,(c)MA-MB最小间隔,(d)VB-MB最大触摸面积
C. 良率猜测和失效形式排行
在实践的制作进程中,心轴/通孔 CD和套准精度等工艺参数被操控在以方针值为中心必定宽度的规模内散布。经过SEMulator3D可主动履行试验规划(DOE)并生成和搜集由用户界说的平均值和规模宽度/标准差。依据搜集的数据和预先设定的良率规矩,即可计算出合格率或良率(即在特定输入条件下,经过合格次数与查验总次数的比率)。 用户还能够依据生成的丈量成果与失效规矩做比照,对失效进行自界说分类。
咱们首要确认了MCD(心轴CD)、VCD(通孔CD)、SPT(侧墙厚度)和MVO(轴心-VCX轴方向套准精度)的均值移动规模及其散布宽度,之后履行试验规划,用蒙特卡洛模仿办法履行3000次虚拟试验测验。图3(a, b)为四种不同输入条件下的失效类别汇总条形图和良率汇总表,经过这些图表能够看出特定输入条件下产生各种失效的概率巨细并由此判别出各类失效形式对良率的影响。
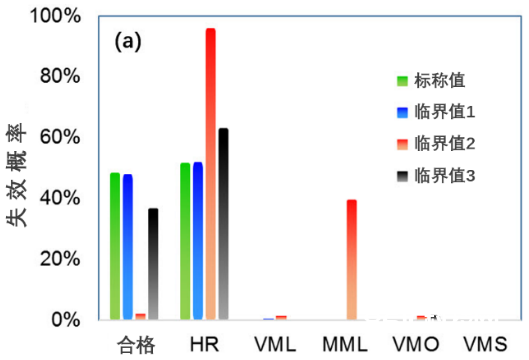

图3. 特定MCD/ VCD/ MVO条件下的良率状况。(a)失效形式条形图,(b)良率汇总
D. 工艺窗口优化
在工艺开发进程中,展开上述剖析可能会引发一系列其他问题,例如猜测所得的良率是否合理?是否可经过调整标准均值取得更高的良率?放宽工艺散布宽度要求的一起能否坚持良率?假如无法到达满足的良率成果,是否能够经过收紧散布宽度以到达方针良率,以及收紧程度怎么?要回答上述问题就要用到SEMulator3D中的工艺窗口优化(PWO)功用。该功用能够主动查找具有固定散布宽度的均值组合,然后再依据所搜集的数据得出最高良率(合格率)的最佳工艺窗口。
表1 所示为工艺参数优化前,优化后,优化后+收紧SPT厚度条件下的良率及其对应的工艺窗口。经过该表能够看出,只需优化工艺标准均值即可将良率从48.4%进步至96.6%,接下来只需进一步收紧SPT散布宽度值即可取得99%的方针良率。

表1.不同输入条件下的良率汇总表
定论
本文讨论了怎么经过虚拟制作进步良率。文中实例选用了因边际定位差错导致VC-M1良率丢失的7nm 6T SRAM模型,选用的技能包含结构构建、模型校准、虚拟量测、失效分类、良率猜测和工艺窗口优化。剖析成果表明经过工艺窗口优化功用和收紧标准要求能够将良率从48.4%进步到99.0%。能够看出,虚拟制作可广泛应用于各种良率进步研讨,而这些研讨的成果将推进半导体工艺和技能的开展。