MEMS器材的封装方法是把依据MEMS的体系计划推向商场的要害要素。研讨发现,当今依据MEMS的典型产品中,封装本钱简直占去了一切物料和拼装本钱的20%~40%。由于出产要素的影响,使得封装之后的测验本钱比器材级的测验本钱更高,这就使MEMS产品的封装挑选和规划愈加重要。
MEMS器材规划团队在开端每项规划前,以及贯穿在整个规划流程中都有必要对封装战略和怎么折中进行考虑和给与极大的重视。许多MEMS产品供给商都会把产品封装作为进行商场竞赛的主要产品差异和竞赛优势。
封装挑选规矩
规划MEMS器材的封装往往比规划一般集成电路的封装愈加杂乱,这是由于工程师常常要遵从一些额定的规划束缚,以及满意作业在严格环境条件下的需求。器材应该能够在这样的苛刻环境下与被丈量的介质十分明显地差异开来。这些介质或许是像枯燥空气相同温文,或许像血液、散热器辐射等相同苛刻。其他的介质还包含进行丈量时的环境,例如,冲击、轰动、温度改动、湿润和EMI/RFI等。
首要,MEMS器材的封装有必要能够和环境进行相互影响。例如,压力传感器的压力输入、血液处理器材的流体进口等。MEMS器材的封装也有必要满意其他一些机械和散热裕量要求。作为MEMS器材的输出,或许是机械电机或压力的改动,因而,封装的机械寄生现象就有或许与器材的功用相互影响和搅扰。
例如,在压阻传感器内,封装应力就会影响传感器的输出。当封装中不同资料混合运用时,它们的胀大和缩短系数不同,因而,这些改动引起的应力就附加在传感器的压力值中。在光学MEMS器材中,由于冲击、轰动或热胀大等原因而发生的封装应力会使光器材和光纤之间的对准发生偏移。在高精度加速度计和陀螺仪中,封装需求和MEMS芯片阻隔以优化功能(见图1)。
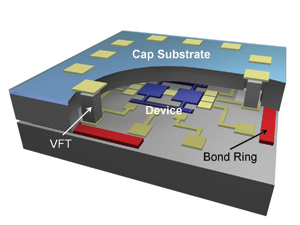
图1 惯例晶圆级封装(WLP)结构示意图
依据出产的MEMS器材类型的不同,电子功能的考虑能够决议所选封装类型的战略。例如,电容传感MEMS器材会发生十分小、并能够被电子器材所辨认的电荷,在规划时就需求特别注意电路和封装中的信号完好性问题。
一般,大多数依据MEMS的体系计划都对MEMS芯片供给相应的电路补偿、操控和信号处理单元。因而,一个MEMS芯片和定制ASIC芯片能够被集成在同一个封装内。相同,电路也能够是集成了MEMS器材的单芯片、单封装(见图2)。
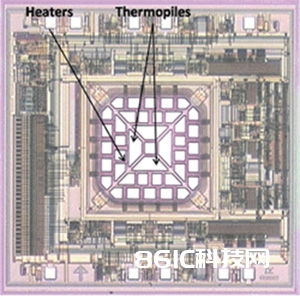
图2 单芯片恒温加速度计
MEMS器材有时也选用晶圆级封装,并用维护帽把MEMS密封起来,完结与外部环境的阻隔或在下次封装前对MEMS器材供给移动维护。这项技能常常用于惯性芯片的封装,如陀螺仪和加速度计。
这样的封装进程是在MEMS流片进程中完结的,需求在洁净环境中依照晶圆处理流程操作。比较而言,集成电路的大部分封装都是在晶圆被切开完结后的芯片级完结的,对封装进程的环境洁净程度没有特别高的要求。
MEMS芯片规划者更乐意运用本钱十分低价的规范封装方法,因而选用塑料封装或与集成电路兼容的封装,这能够运用集成电路工业范畴的本钱优势。运用规范封装也降低了规划和测验时刻,封装自身的本钱也十分低。一个通行的准则是,假如MEMS器材能够安装在PCB板上,它就有或许选用规范集成电路封装方法(见图3)。

图3 微型光机械体系(MOEMS)交流器材的管芯被4条光纤和衔接线衔接,并封装在工业规范的Covar金属封装内
但是,当今绝大多数MEMS器材封装都是客户定制的,并且对特别运用进行了优化。所以,规范集成电路封装不能接受前面所描绘的那些严格条件对介质所带来的影响。
MEMS器材封装的应战是未来所许多运用的两个范畴:医疗电子和轿车电子。在这两类运用中,被丈量的介质关于MEMS器材来说是十分严格的。在轿车电子范畴,需求丈量内燃机机油、燃油、冷却液热辐射、尾气排放等的压力或化学成分。这两个范畴对器材都要求具有高可靠性和极点巩固的特色。所以,长寿命(特别是医用可植入设备)、小尺度(见图4)、生物资料兼容性(见图5)是在挑选封装规划、资料和接口时所面对的最大问题。


图4 无线、无须电池的植入型心脏血流压力波形监督设备


传统ME图5 高密度耳蜗植入体系运用一个石英硅帕拉胶封装工艺,它能够供给杰出的生物兼容性、灵活性和长期运用的安定性。
MS器材封装方法
前期MEMS器材封装方法选用SOC(System-on-Chip:片上体系)技能、以CMOS工艺拼装一个或多个MEMS器材,包含模仿和数字工艺。MEMS产品也能够选用SIP(System-in-Package:封装内体系)技能在前面评论的封装中集成两个或多个芯片。搭接线(wire-bonding)用于衔接封装内的芯片,包含MEMS芯片。如今,这种技能正被集成电路出产范畴中的倒装芯片封装技能所代替(见图6)。

图6 在电信光交流器材(底层管芯)和CMOS操控电路(顶层管芯)的堆叠衔接
在曾经,工程师常常把封装规划留在要害传感器和电路规划完结后的最终阶段。但是,这种规划流程在产品面市压力和剧烈竞赛的冲击下发生了改动,迫使工程师改动他们的规划办法。不然,产品封装的下风将会错失极佳商场窗口。别的,由于规划东西匮乏,当应力或其他影响要素没有被合理评价时,就使得规划失利。
新式开发东西
当时,用于封装规划的新技能现已挨近了MEMS器材制作的水平。硅通孔(TSV)蚀刻技能能够完结高达100多μm的晶圆蚀刻深度。因而,MEMS晶圆厂就能够选用这种和MEMS制作相同等级的技能来制作封装了。
硅通孔(TSV)的运用使别的一种技能得以完结,那就是多芯片堆叠技能。该技能将多个芯片的管芯堆叠在一个封装中,并经过硅通孔衔接在一同。芯片堆叠使芯片的封装更小,但会使封装会变得愈加杂乱。热量有必要在堆叠得极端挨近的芯片之间传递,然后发生散热问题;别的机械结构的稳定性也有必要细心仿真以保证杰出的功能和可靠性。传统的集成电路封装工厂现在也开端供给特别的MEMS器材封装,并且设备供给商也投入开发新的封装和测验设备。因而,MEMS器材的封装挑选是许多的。MEMS器材集成多个传感器,以及与相应的软件配套来供给更高附加值的体系正逐渐向多芯片封装解决计划方向开展。芯片堆叠能够经过一次一片的方法出产,也能够经过晶圆级封装方法进行。
未来开展趋势
封装技能中的一个重要新方向是运用柔性衬底把多个刚性器材封装在一同。多个传感器能够和电子单元及功率模块组合在一同。经过折叠,被封装在一同的体系尺度能够做得十分小。这种技能关于可穿戴人体传感器十分有吸引力。
当集成电路范畴的封装供给商重视其他附加值时,封装的规范化就有或许了,但这需求很长的时刻。在什么地址,由谁来起草这个规范也需求许多的时刻。这是由于MEMS和半导体晶圆厂与传统封装厂之间的竞赛将使最新和最高功能的封装技能得以开发,也使得更多的传统半导体晶圆厂开端为MEMS业界供给服务。