冯 堃,张国俊,王姝娅,戴丽萍,钟志亲(电子科技大学 电子科学与工程学院,成都611731)
摘 要:介绍了一种增大质量块规划的三轴MEMS加速度计。该加速度计依据绝缘体上硅(SOI)硅片,选用双面光刻、干法刻蚀的工艺,使用了部分SOI硅片的底层硅部分来增大加速度计的质量块,规划了依据单一米字形质量块的三轴MEMS电容式微加速度计。依据不同的外界加速度对器材发生的不同位移,研讨了在三个轴向的加速度计的灵敏度,一起剖析了加速度计的穿插轴耦合的影响。最终结合Ansys仿真成果得出:所规划的微加速度计具有较高的灵敏度、抗搅扰能力强、噪声较小的长处,在惯性传感范畴有必定的运用远景。
关键词:微机械系统;三微加速度计;高灵敏度;绝缘体上硅
0 导言
SOI(silicon-on insulator,绝缘体上硅)晶片以其优胜的单晶资料特性、易于完结大厚度器材、易于完结深邃宽比的制造、杰出的机械稳定性、剩余应力小以及后续制造工艺简略的长处逐步在惯性传感器范畴得到广泛运用 [1~5] 。选用SOI晶片的MEMS加速度计很简单完结大的惯性质量块和低布朗噪声。因而,依据SOI的微加速度计是将来惯性传感技能的重要发展方向。H.Hamaguchi等人选用了不等高梳齿电极电容规划制造了Z轴加速度计,并以此为根底完结了三轴线加速度计的规划与制造 [2,3] 。Chia-Pao Hsu等人选用空隙闭合差分电容电极规划在SOI上完结了Z轴加速度计,并选用此技能制成了依据单质量块的三轴加速度计 [6,7] 。
本文研讨的三轴微加速度计选用中心对称米字形结构规划,完结了只运用一个灵敏质量块来检测三个方向的加速度,一起防止了穿插轴搅扰。一起,因为依据SOI硅片制造,使用了SOI硅片的底层硅,得到了更大的质量块,进步了灵敏度。
1 加速度计结构与原理
1.1 加速度计结构
图1为所规划的三轴微加速度计的俯视图。本文中规划的微加速度计为中心对称结构,选用米字形质量块规划,锚点电极选用折叠梁与质量块衔接。因为选用了SOI硅片,能够完结在加工工艺上保存了部分SOI硅片的底层硅部分,增大了加速度计灵敏质量块的质量,然后能够进步微加速度计的灵敏度。在米字形质量块上包含了八组梳齿结构,与其对应的电容为C x1 ,C x2 ,C y1 ,C y2 ,C z1 ,C z2 ,C z3 和C z4 。
四组电容(C x1 ,C x2 ,C y1 和C y2 )结构相同,选用等高梳齿规划,如图2,能够用来丈量平面方向上,即X、Y轴的加速度。其间,C x1 与C x2 是用来丈量X轴加速度的差分电容,C y1 与C y2 是用来丈量Y轴加速度的差分电容。经过使可移动梳齿与固定梳齿之间的距离不同,即d 1 ≠d 2 ,完结了变距离的差分电容的规划,然后进步了可丈量电容的灵敏度。
别的四组电容(C z1 ,C z2 ,C z3 和C z4 )选用不等高梳齿规划,如图3,能够用来丈量Z轴方向上的加速度。其间,C z1 和C z2 方向的可动梳齿高度为固定梳齿高度的一半,两种梳齿的下边际为同一高度;C z3 和C z4 方向的固定梳齿高度为可动梳齿高度的一半,两种梳齿的上边际为同一高度,完结了变面积的差分电容规划,然后进步了可丈量电容的灵敏度。一起,Z轴方向上的可动梳齿与固定梳齿之间的距离持平,均为d 0 ,然后能够起到在电容器上施加调制电压时削减零极点漂移的效果。
在加速度计的完结工艺上,别离经过选用聚酰亚胺和二氧化硅作为深硅刻蚀的掩膜,来分两次进行干法深硅刻蚀来加工完结不等高梳齿。如图2所示,电容C x1 ,C x2 ,C y1 和C y2 地点的梳齿为全高梳齿,需求两种掩膜;如图3所示,电容,C z1 ,C z2 ,C z3 和C z4 地点的梳齿为半高梳齿,需求一种掩膜。为了完结增大质量块的规划,选用了了双面光刻工艺对SOI硅片的反面进行了光刻,这样能够确保部分SOI的底层硅得到保存作为加速度计的质量块的一部分,然后极大增大了惯性质量块的质量。
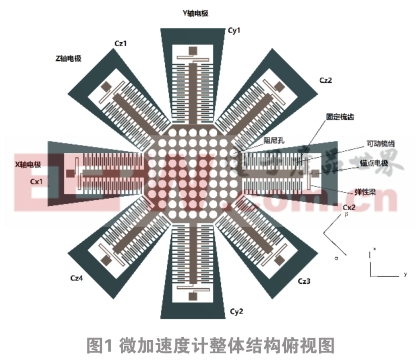


1.2 加速度计原理
所规划的微加速度计传感原理如下:
关于单个平行板电容器的电容与位移的关系为:

其间,ε为介电常数,l,h和d别离代表梳齿电极的长宽高。
则在X轴的电容位移改变关系为:

同理,Y轴的为:

故当质量块在X轴上下方向上一起发生位移时,电容改变只取决于X轴方向上的位移改变;当质量块在Y轴上下方向上一起发生位移时,电容改变只取决于Y轴方向上的位移改变
关于Z轴,别离考虑Z 1,Z2,Z3,Z4 四个方向,一起为了便利评论,以违背XY轴45°方向的α-β为参阅平面。当位移发生在Z轴向上方向时,有


同理,当位移发生在Z轴向下方向时,有

故当质量块在Z轴上下方向上一起发生位移时,电容改变只取决于Z轴方向上的位移改变,即

从上式(3)、(4)和(11)能够看出,∆C x , ∆C y和∆C z 只与三个轴方向上的位移∆x,∆y和∆z有关,故规划的三轴加速度计理论上并不存在两个轴之间的穿插耦合。
2 仿真剖析
微加速度计的资料为晶相100的硅资料,其弹性模量为190Gpa,密度为2330kg/m 3 。微加速度计中心八边形部分质量块边长为500μm,厚度为SOI顶层硅部分60μm和部分底层硅250μm;中心有圆形阻尼孔,为了便利仿真将其等效为一个大的圆孔,其直径为400μm。米字形伸长部分尺度为750μm×100μm×60μm;电容Cx1,Cx2,Cy1和Cy2地点的梳齿厚度H=60μm,电容(Cz1,Cz2,Cz3和Cz4)地点的梳齿厚度h=30μm;停止状况时XY轴方向固定梳齿与可动梳齿的正对部分为120μm×60μm,梳齿距离别离为d 1 =5μm,d 2 =10μm;Z轴方向固定梳齿与可动梳齿的正对部分为120μm×30μm,梳齿距离别离为d 0=30μm。器材总质量为6.31×10 -7kg。
使用Ansys有限元剖析软件对器材进行静力学剖析。别离对器材施加1g的加速度,得到微加速度计三个轴向的位移灵敏度,如表1。

使用Ansys有限元剖析软件对器材进行模态剖析,如图4。
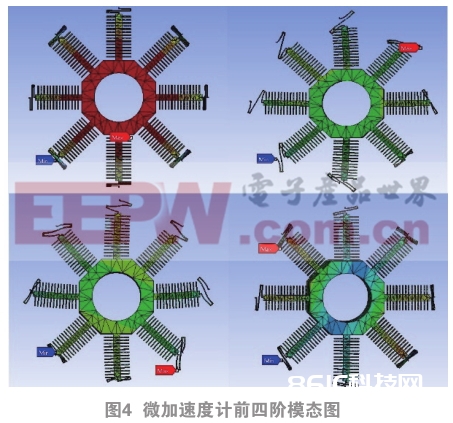

由表2可知,所规划的微加速度计结构对称,前四阶模态为沿Z轴平动、沿X轴平动、沿Y轴平动和沿Z轴滚动。其间,前三阶是所规划的微加速度计的主模态,其他模态是频率为主模态2倍的杂项模态,这样根本能够完结防止杂项模态对主模态的搅扰。一起,三个轴向的共振频率相差较大,阐明所规划的微加速度计的穿插搅扰较小,契合规划方针。
3 加工工艺
本文中的微加速度计的加工工艺流程图如图2所示。(a)选用热氧化工艺在SOI硅片双面热成长厚度为1μm的氧化硅为后续深硅刻蚀的硬掩膜。(b)第一次双面光刻出X轴和Y轴地点的等高梳齿的平面方向区域,RIE刻蚀氧化硅构成图形。(c)在SOI正面顶层硅上进行电子束蒸发铝,然后第2次双面光刻构成电极区域。(d)选用聚酰亚胺(PI)为光刻胶第三次双面光刻整个米字形结构,亚胺化构成第二种后续深硅刻蚀的硬掩膜。(e)第一次深硅刻蚀,刻蚀厚度为顶层硅厚度的一半,然后氧等离子体RIE去除亚胺化后的聚酰亚胺。(f)第2次干法刻蚀,刻蚀到SOI硅片的绝缘层,至此正面结构现已完结。(g)反面第一次双面光刻反面电极区域,RIE刻蚀氧化硅,构成反面第一次干法刻蚀时的硬掩膜,(h)反面第2次双面光刻反面米字形结构,然后亚胺化构成硬掩膜。(i)反面第一次深硅刻蚀,刻蚀厚度为底层硅厚度的一半,然后氧等离子体RIE去除亚胺化后的PI。(j)反面第2次深硅刻蚀,刻蚀到SOI硅片绝缘层。(k)用氢氟酸蒸气去除氧化硅绝缘层和掩膜层,开释结构得到微加速度计。
4 定论
本文所规划的三轴微加速度计选用双面光刻和干法刻蚀工艺,充分使用SOI硅片底层硅部分来增大质量块的质量,差分电容结构规划,使得,灵敏度得到了进步。一起选用全对称的米字形结构,有效地减小了三轴间加速度的穿插耦合搅扰。所规划的微加速度计依据SOI硅片制造,防止了化学机械平整化和键合等工艺,简化了工艺。整体而言,该全对称三轴微加速度计规划合理,具有较小的穿插轴搅扰和较大的灵敏度,有杰出的运用远景。


参阅文献:
[1] MATSUMOTO Y,NISHIMURA M,MATSUURA M,et al. Three-axis SOI capacitive accelerometer with PLL C-V converter[J].Sensors & Actuators A Physical,1999:75 77–85.
[2] TSUCHIYA T,FUNABASHI H. A z-axis differential capacitive SOI accelerometer with vertical comb electrodes[J].Sensors & Actuators A Physical,2004,116(3):378-383.
[3] HAMAGUCHI H,SUGANO K,Tsuchiya T,et al. A DIFFERENTIAL CAPACITIVE THREE-AXIS SOI ACCELEROMETER USING VERTICAL COMB ELECTRODES[C]// Solid-state Sensors, Actuators & Microsystems Conference, Transducers International.IEEE,2007.
[4] ABDOLVAND R ,AMINI B V,Ayazi F.Sub-Micro-Gravity In-Plane Accelerometers With Reduced Capacitive Gaps and Extra Seismic Mass[J].Journal of Microelectromechanical Systems,2007,16(5):1036-1043.
[5] ZAMAN M F,SHARMA A,HAO Z,et al.A Mode-Matched Silicon-Yaw Tuning-Fork Gyroscope With Subdegree-Per-Hour Allan Deviation Bias Instability[J].Journal of Microelectromechanical Systems, 2008, 17(6):1526-1536.
[6] HSU C P,YIP M C,FANG W.Implementation of a gap-closing differential capacitive sensing Z-axis accelerometer on an SOI wafer[J].Journal of Micromechanics & Microengineering,2009,19(7):75006-75007.
[7] HSU C P,HSU Y C,YIP M C,et al. A Novel SOI-Based Single Proof-Mass 3-Axis Accelerometer with Gap-Closing Differential Capacitive Electrodes in All Sensing Directions[C]//Sensors.IEEE,2011.
(注:本文来源于科技期刊《电子产品世界》2020年第05期第59页,欢迎您写论文时引证,并注明出处。)